 |
|
Енергетичні діаграми напівпровідників.
Згідно з уявленнями квантової фізики електрони в атомі можуть приймати строго визначені значення енергії або, як кажуть, займати певні енергетичні рівні. При цьому, в одному і тому ж енергетичному стані не можуть перебувати одночасно два електрони. Тверде тіло, яким є напівпровідниковий кристал, складається з безлічі атомів, сильно взаємодіючих один з одним, завдяки малим міжатомних відстаней. Тому замість сукупності дозволених дискретних енергетичних рівнів, властивих окремому атому, тверде тіло характеризується сукупністю дозволених енергетичних зон, що складаються з великого числа близько розташованих енергетичних рівнів, які називаються зонами. Фіксовані енергетичні зони розділені інтервалами енергій, якими електрони не можуть володіти і які називаються забороненими зонами. Верхня із заповнених електронами дозволених зон називається валентної зоною, а наступна за нею незаповнена зона називається зоною провідності. У напівпровідників валентна зона і зона провідності розділені забороненою зоною. При нагріванні напівпровідника, електронами поглинається додаткова енергія і вони переходять з енергетичних рівнів валентної зони на більш високі енергетичні рівні зони провідності. У провідниках для здійснення таких переходів необхідно незначна енергія, тому провідники характеризуються високою концентрацією вільних електронів (порядку 1022 см-3). У напівпровідниках для того, щоб електрони змогли перейти з валентної зони в зону провідності, ними повинна бути поглинута енергія не менше ширини забороненої зони. Це і є енергія, яка необхідна для розриву ковалентних зв'язків.
На рис. а), б), в) представлені енергетичні діаграми власного, електронного та діркового напівпровідників, на яких через EC позначена нижня межа зони провідності, а через EV - верхня межа валентної зони. Ширина забороненої зони DEз = EC-EV. Для кремнію вона дорівнює 1,1 еВ, в германію - 0,7 еВ.
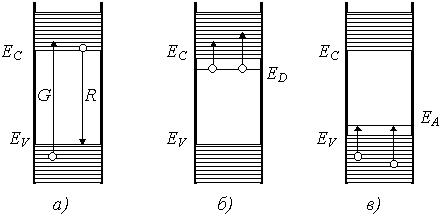 З точки зору зонної теорії під генерацією вільних носіїв заряду слід розуміти перехід електронів з валентної зони в зону провідності (мал.а)). У результаті таких переходів у валентній зоні з'являються вільні енергетичні рівні, відсутність електронів на яких слід трактувати як наявність на них фіктивних зарядів - дірок. Перехід електронів із зони провідності у валентну зону слід трактувати як рекомбінацію рухомих носіїв заряду. Чим ширше заборонена зона, тим менше електронів здатні подолати її. Цим пояснюється більш висока концентрація електронів і дірок в германії в порівнянні з кремнієм. В електронному напівпровіднику (рис.б)) за рахунок наявності п’ятивалентних домішок у межах забороненої зони поблизу дна зони провідності з'являються дозволені рівні енергії ED. Оскільки один домішковий атом припадає приблизно на 106 атомів основної речовини, то домішкові атоми практично не взаємодіють один з одним. Тому домішкові рівні не утворюють енергетичну зону і їх зображують як один локальний енергетичний рівень ЕD, на якому перебувають "зайві" електрони домішкових атомів, не зайняті у ковалентних зв'язках. енергетичний інтервал DEі = EС-ED називається енергією іонізації. Величина цієї енергії для різних п’ятивалентних домішок лежить у межах від 0,01 до 0,05 еВ, тому "зайві" електрони легко переходять у зону провідності.
З точки зору зонної теорії під генерацією вільних носіїв заряду слід розуміти перехід електронів з валентної зони в зону провідності (мал.а)). У результаті таких переходів у валентній зоні з'являються вільні енергетичні рівні, відсутність електронів на яких слід трактувати як наявність на них фіктивних зарядів - дірок. Перехід електронів із зони провідності у валентну зону слід трактувати як рекомбінацію рухомих носіїв заряду. Чим ширше заборонена зона, тим менше електронів здатні подолати її. Цим пояснюється більш висока концентрація електронів і дірок в германії в порівнянні з кремнієм. В електронному напівпровіднику (рис.б)) за рахунок наявності п’ятивалентних домішок у межах забороненої зони поблизу дна зони провідності з'являються дозволені рівні енергії ED. Оскільки один домішковий атом припадає приблизно на 106 атомів основної речовини, то домішкові атоми практично не взаємодіють один з одним. Тому домішкові рівні не утворюють енергетичну зону і їх зображують як один локальний енергетичний рівень ЕD, на якому перебувають "зайві" електрони домішкових атомів, не зайняті у ковалентних зв'язках. енергетичний інтервал DEі = EС-ED називається енергією іонізації. Величина цієї енергії для різних п’ятивалентних домішок лежить у межах від 0,01 до 0,05 еВ, тому "зайві" електрони легко переходять у зону провідності.
У дирковому напівпровіднику введення тривалентних домішок веде до появи дозволених рівнів ЕA (pис. в)), які заповнюються електронами, що переходять на нього з валентної зони, в результаті чого утворюються дірки. Перехід електронів з валентної зони в зону провідності вимагає більших витрат енергії, ніж перехід на рівні акцепторів, тому концентрація електронів np виявляється менше концентрації ni, а концентрацію диpок pp можна вважати приблизно рівною концентрації акцепторів NA.
| №3. Л | Тема: P-n як основа напівпровідникових пристроїв. |
| 1. Механізм утворення p-n переходу. | |
| 2. P-n перехід в зовнішньому електричному полі. |
1. Механізм утворення p-n переходу.
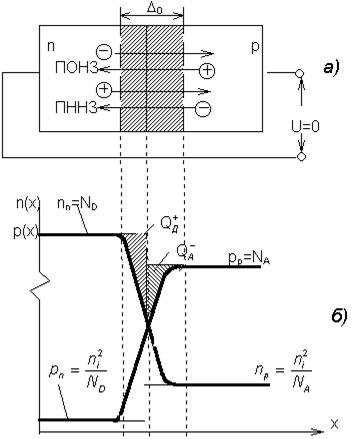 В основі більшості напівпровідникових діодів і транзисторів лежить контакт двох напів-провідників з різним типом електропро-відності. Такий контакт називають електронно-дірковим переходом або p-n переходом. Він може бути отриманий, наприклад, шляхом дифузії донорної домішки в напівпровідник p-типу. Ідеалізована одномірна структура p-n переходу зображена на рис. а). Для простоти будемо вважати, що концентрація легуючої домішки в областях n і p типу розподілена рівномірно, причому концентрація донорної домішки ND в n-напівпровіднику значно більше, ніж концентрація акцепторної домішки NA в p-напівпровіднику (ND>> NA). Область із більшою концентрацією домішки назвається емітером, а область із меншою концентрацією домішки - базою. Це припущення дозволяє вважати, що повний струм через p-n перехід визначається переважно складовою струму із емітера в базу (в даному випадку - електрон-ною складовою, а діркова складова струму через p-n перехід мала і нею можна знехтувати):
В основі більшості напівпровідникових діодів і транзисторів лежить контакт двох напів-провідників з різним типом електропро-відності. Такий контакт називають електронно-дірковим переходом або p-n переходом. Він може бути отриманий, наприклад, шляхом дифузії донорної домішки в напівпровідник p-типу. Ідеалізована одномірна структура p-n переходу зображена на рис. а). Для простоти будемо вважати, що концентрація легуючої домішки в областях n і p типу розподілена рівномірно, причому концентрація донорної домішки ND в n-напівпровіднику значно більше, ніж концентрація акцепторної домішки NA в p-напівпровіднику (ND>> NA). Область із більшою концентрацією домішки назвається емітером, а область із меншою концентрацією домішки - базою. Це припущення дозволяє вважати, що повний струм через p-n перехід визначається переважно складовою струму із емітера в базу (в даному випадку - електрон-ною складовою, а діркова складова струму через p-n перехід мала і нею можна знехтувати):
Прослушать
i = in + ip » in.
Розподіл концентрації електронів уздовж осі x показано на рис. б). Так як концентрація електронів в n-напівпровіднику nn (основні носії заряду) значно перевищує концентрацію електронів в p-напівпровіднику np (неосновні носії заряду), то в площині контакту виникає дифузія електронів з n-області у p-область. Аналогічні міркування приводять до дифузії дірок з p-області у n-область. Таким чином через p-n перехід протікають дифузійні потоки основних носіїв заряду (ПОНЗ).
Коли електрони переходять з напівпровідника n-типу в p-область, вони залишають у приконтактній області n-напівпровідника нескомпенсований позитивний нерухомий заряд іонів донорів QD+. Аналогічно в приконтактній області p-напівпровідника з'являється рівний за величиною нескомпенсований негативний нерухомий заряд іонів акцепторів QA-. На рисунку б) відповідні області заштриховані й позначені. Таким чином в області контакту з'являється вбудоване електричне поле локалізоване поблизу кордону x0. Будемо характеризувати його контактною різницею потенціалів jK. Поле що виникло перешкоджає руху основних носіїв через перехід і є причиною появи зустрічного дрейфового руху електронів з p-області у n-область.
Таким чином, потоки неосновних носіїв заряду по своїй природі є дрейфові.
2. P-n перехід в зовнішньому електричному полі.
Розглядаючи процеси в p-n переході при подачі зовнішньої напруги будемо так само вважати, що опір збідненої області, де рухомих носіїв заряду практично немає, значно більше, ніж опір областей n та p типу поза переходом. Це допущення дозволить вважати, що вся зовнішня напруга падає на p-n переході, а контактна різниця потенціалів на кінцях напівпровідника, відповідно змінюється до величини jK±Uзовнішнє, де знак "+" відповідає накладанню прямої напруги на p-n перехід (рис.а), а знак "-" подачі зворотньої напруги (рис.г).
Розподіл потенціалу вздовж структури p-n переходу показаний на рис.б та рис.д.

При прямій напрузі (Uзовнішнє>0) зменшення потенційного бар'єру призводить до переважання потоку електронів з емітера в базу (ПОНЗ) над потоком електронів з бази в емітер (ПННЗ). При цьому електрони інжектуються в базу, концентрація електронів на кордоні xp зростає і значно перевищує рівноважну концентрацію в базі. Таким чином, інжекція електронів базу призводить до появи нерівноважних носіїв у базі. Внаслідок виникнення перепаду концентрації в базі починається процес дифузії електронів від межі переходу xp в глибину p-бази. По мірі руху нерівноважна концентрація зменшується за рахунок рекомбінації. Таким чином, три процеси визначають розподіл нерівноважної концентрації в базі p-n переходу при прямій напрузі:
Інжекція - викликає збільшення граничної концентрації, тобто приводить до появи нерівноважних носіїв заряду в базі;
Дифузія - є причиною руху електронів через базу;
Рекомбінація - призводить до зменшення нерівноважної концентрації в базі далеко від p-n переходу.
Провівши аналогічні міркування для зворотного зміщення, зазначимо таке: p-n перехід при зворотному зміщенні екстрагує (виводить) електрони з бази. Гранична концентрація зменшується в порівнянні з рівноважною. Три процеси визначають зворотний струм p-n переходу:
Екстракція електронів з бази;
Дифузія їх з глибини бази до межі переходу;
Генерація пар електрон - дірка в області переходу.
Збільшення температури p-n переходу приводить до збільшення теплового струму, а, отже, до зростання прямого і зворотного струмів.
Збільшення концентрації легуючих домішок призводить до зменшення теплового струму, а, отже, до зменшення прямого і зворотного струмів p-n переходу.
| №4. ПР | Тема: ВАХ p-n переходу. |
| 1. ВАХ ідеального p-n переходу. | |
| 2. ВАХ реального p-n переходу. | |
| 3. Вплив температури на ВАХ p-n переходу. | |
| 4. Ємності p-n переходу. |
-
 ВАХ ідеального p-n переходу.
ВАХ ідеального p-n переходу.
ВАХ p-n-переходу описується виразом:
де i0 - тепловий струм p-n переходу, який визначається фізичними властивостями напівпровід-никового матеріалу та температурою;
U - напруга, прикладена до р-n переходу;
ехр - основа натуральних логарифмів;
q - заряд електрона;
k - постійна Больцмана;
Т - абсолютна температура р-n переходу.
 -температурний потенціал, при кімнатній температурі рівний приблизно 0,025 В.
-температурний потенціал, при кімнатній температурі рівний приблизно 0,025 В.
 На рис. побудована ВАХ ідеального p-n-переходу. При побудові ВАХ приймемо T = 300К, тоді kT / q = 0,026 В.
На рис. побудована ВАХ ідеального p-n-переходу. При побудові ВАХ приймемо T = 300К, тоді kT / q = 0,026 В.
Оцінимо прямий і зворотній струми p-n переходу при подачі зовнішньої напруги U = ± 0,26 В.
При прямій напрузі U = 0,26 В:
i = i0 • [e10 - 1] = i0 • e10>> i0
Таким чином, вже при U = 0,26 В величина прямого струму значно перевищує тепловий струм p-n переходу.
При зворотній напрузі U = - 0,26 В:
i = i0 · [e–10 – 1]» - i0.
В таблиці наведені дані, про значення відношення струму через перехід до теплового струму при прямій напрузі (Iпрямий / I0) та при зворотній напрузі (Iзворотній / I0) при різних величинах прикладеної зовнішньої напруги.
| U, В | 0,025 | 0,05 | 0,075 | 0,1 | 0,15 | 0,2 | 0,25 |
| Iпрямий / I0 | 1,71 | 6,3 | |||||
| Iзворотній / I0 | -0,42 | -0,84 | -0,95 | -0,98 | -0,998 | » - 1 | » - 1 |
Таким чином, при зворотній напрузі через p-n перехід протікає тепловий струм i0, значення якого не залежить від величини прикладеної зворотної напруги.
 ВАХ p-n переходу представляє собою нелінійну залежність між струмом і напругою. В загальному випадку до p-n переходу може бути докладено як постійну напругу, що визначає робочу точку на характеристиці, так і змінну напругу, амплітуда якого визначає переміщення робочої точки по характеристиці. Якщо амплітуда змінної напруги мала, переміщення робочої точки не виходить за межі малої ділянки характеристики і її можна замінити прямою лінією. Тоді між малими амплітудами струму і напруги (або між малими приростами струму і напруги Δi та ΔU) існує лінійний зв'язок. У цьому випадку p-n перехід на змінному струмі характеризують диференційним опором rpn:
ВАХ p-n переходу представляє собою нелінійну залежність між струмом і напругою. В загальному випадку до p-n переходу може бути докладено як постійну напругу, що визначає робочу точку на характеристиці, так і змінну напругу, амплітуда якого визначає переміщення робочої точки по характеристиці. Якщо амплітуда змінної напруги мала, переміщення робочої точки не виходить за межі малої ділянки характеристики і її можна замінити прямою лінією. Тоді між малими амплітудами струму і напруги (або між малими приростами струму і напруги Δi та ΔU) існує лінійний зв'язок. У цьому випадку p-n перехід на змінному струмі характеризують диференційним опором rpn:
При прямій напрузі rpn малий і складає одиниці - сотні ом, а при зворотній напрузі - великий і складає сотні і тисячі кілоом. Диференційний опір rpn можна визначити графічно за ВАХ де вказані DU та Di
- ВАХ реального p-n переходу.
 На рис. наведена ВАХ реального p-n переходу, тут же пунктиром показана ВАХ ідеального p-n переходу. Розглянемо основні причини, що призводять до відмінності характеристик.
На рис. наведена ВАХ реального p-n переходу, тут же пунктиром показана ВАХ ідеального p-n переходу. Розглянемо основні причини, що призводять до відмінності характеристик.
 При прямій напрузі на p-n переході (область 1) відхилення реальної характеристики від ідеальної пов'язано з кінцевим (не нульовим) опором слаболегованної області бази - rБ. Частина зовнішнього напруги падає на об'ємному опорі бази rБ, тому напруга на p-n переході зменшується до величини Upn=Uпряме - rБ • iрn. З урахуванням опору бази, прямий струм реального p-n переходу описується рівнянням:
При прямій напрузі на p-n переході (область 1) відхилення реальної характеристики від ідеальної пов'язано з кінцевим (не нульовим) опором слаболегованної області бази - rБ. Частина зовнішнього напруги падає на об'ємному опорі бази rБ, тому напруга на p-n переході зменшується до величини Upn=Uпряме - rБ • iрn. З урахуванням опору бази, прямий струм реального p-n переходу описується рівнянням:
Таким чином, при однаковій величині прямої напруги струм реального p-n переходу буде менше, ніж ідеального.
Наростання падіння напруги на діоді при великих струмах відхиляється від експоненціального вигляду і стає більш лінійним. Це пояснюється тим, що стає помітним падіння напруги на омічному об'ємному опорі напівпровідника, з якого сформовано діод.
При зворотній напрузі зворотний струм реального переходу виявляється більшим, ніж струм ідеального переходу, а, крім того, величина зворотного струму залежить від зворотньої напруги (область 2 на рис.). Причиною цього відмінності є теплова генерація в області об'ємного заряду. Внаслідок малої концентрації носіїв заряду в p-n переході, швидкість генерації пар носіїв заряду в цій області переважає над швидкістю рекомбінації; будь-яка пара носіїв заряду, що генерується в цій області, розділяється полем переходу, а отже, до теплового струму додається генераційна складова. Величина струму генерації пропорційна ширині p-n переходу, а отже, залежить від прикладеної зворотної напруги. Для германієвих p-n переходів обидві складові зворотного струму одного порядку; для кремнієвих p-n переходів струм генерації на кілька порядків може перевищувати тепловий струм.
При досить великих зворотніх напругах (область 3 на рис.) в p-n переході може статися пробій. Пробоєм називається необмежене збільшення струму при постійній або навіть меншій напрузі на p-n переході. Розрізняють три види пробою: лавинний, тунельний, тепловий.
Лавинний пробій (область 3, ) пов'язаний з виникненням ударної іонізації атомів напівпровідника в області об'ємного заряду при високій напруженості електричного поля. При великих зворотних напругах процес ударної іонізації лавиноподібно наростає, що призводить до збільшення зворотного струму.
Тунельний пробій пов'язаний з тунельними переходами електронів крізь вузький і високий потенційний бар'єр. Такий пробій виникає в p-n переходах на базі сильнолегованих областей n та p-типу.
Лавинний і тунельний пробої озворотні, тобто при включенні в коло p-n переходу обмежуючого струм опору ці види пробою не призводять до руйнування самого переходу.
Тепловий пробій (область 4, рис.) настає за умови, коли потужність, що виділяється в p-n переході виявляється більшою, ніж потужність, що відводиться. У цьому випадку температура p-n переходу лавиноподібно зростає, що в кінцевому рахунку призводить до незворотного руйнування p-n переходу. Щоб запобігти тепловому пробою, необхідно покращувати тепловідвід від p-n переходу.
ПрослушатьНа латиницСловарь - Открыть словарную статью
3.Вплив температури на ВАХ p-n переходу.
 Вольтамперні характеристики p-n переходу для двох значень температури навколишнього середовища наведено на рис. Із зростанням температури падає пряма напруга на p-n переході при заданому струмі, і при заданій зворотній напрузі збільшується зворотний струм.
Вольтамперні характеристики p-n переходу для двох значень температури навколишнього середовища наведено на рис. Із зростанням температури падає пряма напруга на p-n переході при заданому струмі, і при заданій зворотній напрузі збільшується зворотний струм.
Прямий струм p-n переходу визначається потоком основних носіїв заряду, який залежить від величини потенційного бар'єру в p-n переході. Збільшення температури приводить до зменшення потенційного бар'єру, а отже, до збільшення прямого струму. Зворотний струм p-n переходу визначається потоком неосновних носіїв заряду. Збільшення температури приводить до збільшення швидкості теплової генерації, що приводить до зростання концентрації неосновних носіїв заряду в напівпровіднику, а отже, зростання зворотного струму.
Для кількісної оцінки впливу температури на ВАХ p-n переходу використовують два параметри:
 Температурний коефіцієнт напруги (ТКН) показує, на скільки зміниться пряма напруга на p-n переході (DU) при заданій зміні температури (DТ) при постійному струмі через p-n перехід:
Температурний коефіцієнт напруги (ТКН) показує, на скільки зміниться пряма напруга на p-n переході (DU) при заданій зміні температури (DТ) при постійному струмі через p-n перехід:
Для германієвих p-n-переходів ТКН »-2 мВ/град,
для кремнієвих p-n-переходов ТКН »-3 мВ/град.
 Температура подвоєння зворотного струму p-n-переходу Т* дозволяє розрахувати зворотний струм iЗВОР(Т0 + DТ) при зростанні температури на DТ за відомим значенням зворотного струму при заданій температурі Т0:
Температура подвоєння зворотного струму p-n-переходу Т* дозволяє розрахувати зворотний струм iЗВОР(Т0 + DТ) при зростанні температури на DТ за відомим значенням зворотного струму при заданій температурі Т0:
Для германієвих p-n переходів зворотний струм подвоюється на кожні 10°C (Т*=10°C), для кремнієвих – на кожні 8°C (Т * = 8°С).
3.Ємності p-n переходу.
 При подачі на p-n перехід змінної напруги в ньому проявляються ємнісні властивості. Утворення p-n переходу пов'язане з виникненням просторового заряду, створюваного нерухомими іонами атомів донорів і акцепторів. Прикладена до p-n переходу зовнішня напруга змінює величину просторового заряду в переході. Отже, p-n перехід веде себе як своєрідний плоский конденсатор, обкладинками якого служать області n і p типу поза переходом, а ізолятором є область просторового заряду, збіднена носіями заряду, яка має великий опір. Така ємність p-n переходу назива-ється бар'єрною - Сб. Особливістю бар'єрної ємності є її залеж-ність від зовнішньої прикладеної напруги. Залежність Сб=f(Uзвор) називається вольтфарадною характеристикою - ВФХ (рис.). Залежно від площі переходу, концентрації легуючої домішки і зворотного напруги Сбможе набувати значення від одиниць до сотень пікофарад. Бар'єрна ємність проявляється при зворотній напрузі; при прямій напрузі вона шунтується малим опором переходу rpn.
При подачі на p-n перехід змінної напруги в ньому проявляються ємнісні властивості. Утворення p-n переходу пов'язане з виникненням просторового заряду, створюваного нерухомими іонами атомів донорів і акцепторів. Прикладена до p-n переходу зовнішня напруга змінює величину просторового заряду в переході. Отже, p-n перехід веде себе як своєрідний плоский конденсатор, обкладинками якого служать області n і p типу поза переходом, а ізолятором є область просторового заряду, збіднена носіями заряду, яка має великий опір. Така ємність p-n переходу назива-ється бар'єрною - Сб. Особливістю бар'єрної ємності є її залеж-ність від зовнішньої прикладеної напруги. Залежність Сб=f(Uзвор) називається вольтфарадною характеристикою - ВФХ (рис.). Залежно від площі переходу, концентрації легуючої домішки і зворотного напруги Сбможе набувати значення від одиниць до сотень пікофарад. Бар'єрна ємність проявляється при зворотній напрузі; при прямій напрузі вона шунтується малим опором переходу rpn.
Крім бар'єрної ємності p-n перехід має так звану дифузійну ємність CДИФ. Дифузійна ємність пов'язана з процесами накопичення та розсмоктування нерівноважного заряду в базі і характер-ризує інерційність руху нерівноважних зарядів в області бази. Величина дифузійної ємності пропорційна струму через p-n перехід. При прямій напрузі значення дифузійної ємності може досягати десятків тисяч пікофарад. Сумарна ємність p-n переходу визначається сумою бар'єрної та дифузійної ємностей. При зворотній напрузі Cб>CДИФ; при прямій напрузі переважає дифузійна ємність CДИФ >> Cб.
 Прослушать
Прослушать
Pry podachi na pn-perekhid zminnoï napruhy proyavlyayutʹsya yemnisni vlastyvosti.
Osvita pn-perekhodu pov'yazano z vynyknennyam prostorovoho zaryadu, stvoryuvanoho nerukhomymy ionamy atomiv donoriv i aktseptoriv. Prykladenu do pn-perekhodu zovnishnya napruha zminyuye velychynu prostorovoho zaryadu v perekhodi. Otzhe, pn perekhid vede sebe yak svoyeridnyy̆ ploskyy̆ kondensator, obkladynkamy yakoho sluzhatʹ oblasti n-i p-typu poza perekhodu, a izolyatorom ye oblastʹ prostorovoho zaryadu, zbidnena nosiyamy zaryadu i maye velykyy̆ opir.
Taka yemnistʹ pn-perekhodu nazyvayetʹsya bar'yernoï. Osoblyvistyu bar'yernoï yemnosti ye ïï zalezhnistʹ vid zovnishnʹoho prykladenoï napruhy.
Zalezhnistʹ bar'yernoï yemnosti vid zvorotnoho napruhy nazyvayetʹsya volʹtfaradnoy̆ kharakterystykoyu (dyv. rys. 2.6). Zalezhno vid ploshchi perekhodu, kontsentratsiï lehuyuchoï domishky i zvorotnoho napruhy bar'yerna yemnistʹ mozhe nabuvaty znachennya vid odynytsʹ do sotenʹ pikofarad. Bar'yerna yemnistʹ vyyavlyayetʹsya pry zvorotnomu napruzi; pry pryamomu napruzi vona shuntuyetʹsya malym oporom rpn.
Krim bar'yernoï yemnosti pn-perekhid maye tak zvanoï dyfuziy̆noï yemnistyu. Dyfuziy̆na yemnistʹ pov'yazana z protsesamy nakopychennya ta rozsmoktuvannya nerivnovazhnoho zaryadu v bazi i kharakteryzuye inertsiy̆nistʹ rukhu nerivnovazhnykh zaryadiv v oblasti bazy.
Velychyna dyfuziy̆noï yemnosti proportsiy̆na strumu cherez pn-perekhid. Pry pryamomu napruzi znachennya dyfuziy̆noï yemnosti mozhe dosyahaty desyatkiv tysyach pikofarad. Sumarna yemnistʹ pn-perekhodu vyznachayetʹsya sumoyu bar'yernoï ta dyfuziy̆noï yemnostey̆. Pry zvorotnomu napruzi CB> CDIF; pry pryamomu napruzi perevazhaye dyfuziy̆na yemnistʹ CDIF>> CB.
Словарь - Открыть словарную статью
Еквівалентна схема p-n переходу на змінному струмі представлена на рис. На ній паралельно диференційному опору p-n переходу rpn включені дві ємності Cб та CДИФ;
послідовно з rpn ввімкнений об'ємний опір бази rБ. Зі зростанням частоти змінної напруги, поданої на p-n перехід, ємнісні властивості проявляються все сильніше, rpn шунтується ємнісним опором і загальний опір p-n переходу визначається об'ємним опором бази. Таким чином, на високих частотах p-n перехід втрачає свої нелінійні властивості.
| №5. Л | Тема: Випрямні діоди. Стабілітрони. Варикапи. Імпульсні діоди. |
| 1. Випрямні діоди. Параметри, характеристики області застосування. | |
| 2. Стабілітрони. Параметри, характеристики області застосування. | |
| 3. Варикапи. Параметри, характеристики області застосування. | |
| 4. Імпульсні діоди. Параметри, характеристики області застосування. |
Напівпровідниковий діод - це напівпровідниковий прилад з одним переходом і двома відводами.
 В якості випрямляючого електричного переходу використовується електронно-дірковий р-n перехід, що розділяє р та n області кристала напівпровідника. По суті, до р і n областей кристалу приварюються або припаюються металеві відводи, і вся конструкція монтується в металевий, металокерамічний, скляний або пластмасовий корпус. Тому основні характеристики і параметри діода визначаються властивостями переходу. Перш за все, це його випрямляючі властивості.
В якості випрямляючого електричного переходу використовується електронно-дірковий р-n перехід, що розділяє р та n області кристала напівпровідника. По суті, до р і n областей кристалу приварюються або припаюються металеві відводи, і вся конструкція монтується в металевий, металокерамічний, скляний або пластмасовий корпус. Тому основні характеристики і параметри діода визначаються властивостями переходу. Перш за все, це його випрямляючі властивості.
Так як зворотні струми невеликі, а індивідуальний розкид може бути значними, то в технічній документації діода вказують максимально можливі їх величини, отримані за певних умов. Обчислення прямого струму через діод проводять за формулою:
де m – поправочний коефіцієнт, для кремнієвих діодів може приймати значення 2 і вище.
Нормальна робота діода в якості елемента з односторонньою провідністю можлива лише в режимах, коли зворотня напруга не перевищує пробивного значення. Можливість теплового пробою діода враховується вказаною в паспорті на прилад допустимою зворотною напругою Uзвор.max і температурного діапазону роботи. Напруга пробою залежить від типу діода і температури навколишнього середовища.
 Пряма гілка ВАХ германієвих діодів починається практично з початку координат, кремнієвих діодів - розташована значно правіше, і ще більший зсув у діодів на основі сполук галію. Помітні струми у малопотужних кремнієвих діодів починаються при прямих напругах 0,2 ... 0,5 В, світлодіодів - 1,2 ... 1,6 В. Можна вважати, що у діодів є деяка порогова напруга Uпор, нижче якої прямий струм через діод дорівнює нулю.
Пряма гілка ВАХ германієвих діодів починається практично з початку координат, кремнієвих діодів - розташована значно правіше, і ще більший зсув у діодів на основі сполук галію. Помітні струми у малопотужних кремнієвих діодів починаються при прямих напругах 0,2 ... 0,5 В, світлодіодів - 1,2 ... 1,6 В. Можна вважати, що у діодів є деяка порогова напруга Uпор, нижче якої прямий струм через діод дорівнює нулю.
Діоди, виконані на основі переходу Шотки (діоди Шотки), мають менше пряме падіння напруги та більшу швидкодію, ніж діоди з p-n переходом. Ці переваги визначають області застосування діодів Шотки - виготовлення потужних високочастотних випрямних діодів.
Умовні графічні позначення  напівпровідникових діодів: 1 - випрямний або імпульсний діод; 2 - стабілітрон і стабістор; 3 - симетричний стабілітрон; 4 - Варикап; 5 - тунельний діод; 6 - світловипромінюючий діод; 7 –
напівпровідникових діодів: 1 - випрямний або імпульсний діод; 2 - стабілітрон і стабістор; 3 - симетричний стабілітрон; 4 - Варикап; 5 - тунельний діод; 6 - світловипромінюючий діод; 7 –
фотодіод.