 |
|
Плазменное травление (ПТ)
При плазменном травлении обрабатываемый образец помещается непосредственно в область химически активной плазмы, располагаясь на специальном подложкодержателе и находится обычно под плавающим потенциалом. Основными частицами, участвующими в процессе плазменного травления и влияющими на него, являются свободные атомы, радикалы, ионы и электроны. Вклад этих частиц в плазменное травление различен: химически активные частицы, т. е. свободные атомы и радикалы, вступают в химическую реакцию с поверхностными атомами материалов и удаляют поверхностные слои в результате образования летучих продуктов реакции, а электроны и ионы активируют эту реакцию, увеличивая скорость травления. Активирующее воздействие ионов и электронов определяется энергией, с которой они бомбардируют обрабатываемую поверхность. Значение этой энергии зависит от потенциала обрабатываемой поверхности относительно плазмы. Вследствие различия в подвижности электронов и ионов на поверхности, находящейся в плазме (если она не заземлена и на нее не подается напряжение), возникает отрицательный плавающий потенциал, который зависит от мощности, вкладываемой в разряд, давления и вида газа и при плазменном травлении обычно не превышает нескольких десятков вольт (напомним, что к плазменному травлению относятся процессы, в которых энергия ионов не превышает 100 эВ). Таким образом, величина разности потенциалов между плазмой и обрабатываемой поверхностью не может обеспечить заряженным частицам энергию, достаточную для эффективного физического распыления (при 100 эВ коэффициент распыления не превышает 0,1 атом/ион). Но в то же время энергия ионов и электронов достаточна для разрушения химической связи между поверхностными атомами материала, активации химической реакции и стимулирования процессов десорбции образующихся продуктов. В результате скорость травления возрастает. Кроме этого, положительные ионы сами обладают химической активностью и могут вступать в реакцию. В большинстве случаев вклад химической реакции между ионами и материалом в плазменном травлении незначителен по сравнению с вкладом химической реакции с участием нейтральных активных частиц. Это объясняется тем, что концентрация ионов в плазме (109 – 1011 см-3) значительно ниже концентрации нейтральных активных частиц (1014 – 1016 см-3).
Генерацию энергетически и химически активных частиц для осуществления плазменного травления производят в реакторах, которые в зависимости от вида конкретного процесса должны удовлетворять определенным требованиям. В первую очередь, должны обеспечиваться заданные скорость и равномерность процесса при приемлемых мощности разряда и расходе рабочего газа. Таким требованиям удовлетворяют реакторы с объемным расположением подложек в плазме и реакторы диодного типа, в которых подложки размещают на плоских электродах.
Реакторы с объемным расположением подложек чаще всего имеют цилиндрическую форму и выполняются из кварца. Примеры конструктивных решений таких реакторов схематично изображены на рис. 1

Рис. 1. Типичные схемы реакторов плазменного травления: 1 – вакуумная камера, 2 – линия напуска газа, 3 – линия откачки, 4 – обрабатываемые подложки, 5 – индуктор, 6 – конденсаторные обкладки.
Общей чертой всех реакторов объемного типа является кассетная загрузка подложек. Одновременно в реакторе может обрабатываться 20-100 подложек. Высокая производительность установок - их главное достоинство. В то же время кассетная загрузка подложек имеет существенные недостатки. Во-первых, это большая суммарная площадь обрабатываемой поверхности и, как следствие, возможность проявления загрузочного эффекта. Во-вторых, для получения стабильных результатов травления при обработке пластин партиями необходима высокая точность поддержания рабочих параметров от цикла к циклу, что является сложной технической задачей.
Основными рабочими параметрами, определяющими характеристики процесса плазменного травления, являются: мощность, вкладываемая в разряд, рабочее давление, расход газа и способ его подвода к обрабатываемой поверхности, температура подложек, состав используемого газа.
При проведении ПТ важен выбор не только рабочего газа, но и добавок к нему, которые, не принимая непосредственного участия в процессе травления, могут существенно увеличить эффективность использования основного газа. Основным механизмом влияния газа-добавки на скорость ПТ является увеличение концентрации ХАЧ в реакторе, которое может реализоваться через:
1) уменьшение вероятности рекомбинации ХАЧ на стенках реактора и 2) увеличение скорости генерации ХАЧ. Последний механизм может реализоваться как через появление дополнительных каналов диссоциации молекул при взаимодействии с возбужденными частицами газов-добавок, так и через увеличение скорости диссоциации электронным ударом при изменении электрофизических параметров плазмы.
Наличие эффекта увеличения скорости травления при подаче на обрабатываемый материал смещения как отрицательной, так и положительной полярности свидетельствует о том, что процесс ПТ одинаково эффективно активируется как ионной, так и электронной бомбардировкой. Хотя оба этих фактора затрудняют адсорбцию ХАЧ, они оказывают стимулирующее действие на химическую реакцию на поверхности и десорбцию продуктов взаимодействия. При подаче положительного смещения определенную роль могут играть отрицательные ионы, которые рекомбинируют на поверхности с образованием нейтральных ХАЧ.
Влияние поперечного магнитного поля связано с изменением траектории движения электрона (закручивания в спираль) и увеличением частоты столкновений, приводящих к образованию ХАЧ.
Селективность ПТ зависит от операционных параметров процесса. Рост интенсивности ионной бомбардировки с ростом вкладываемой мощности приводит к снижению селективности. Селективность существенно увеличивается с ростом давления и расхода газа, характер этого влияния обусловлен тем, что ПТ кремния обычно происходит в диффузионной области, а SiO2 – в кинетической. Значительного увеличения селективности можно достичь при добавлении к фторсодержащим газам кислорода, который уменьшает рекомбинацию атомов фтора и повышает скорость травления кремния. Увеличение интенсивности ионной бомбардировки приводит к росту скорости процесса, протекающего в кинетическом режиме, а рост площади обрабатываемой поверхности сказывается только на скорости реакции в диффузионной области. Влияние частоты ВЧ поля связано со снижением скорости травления оксида кремния из-за изменения условий ионной бомбардировки.
При производстве ИМС с субмикронными размерами элементов ПТ может быть применено только для формирования топологии в пленках толщиной более 0.5 мкм. Это обусловлено значительным подтравливанием под маскирующий слой, при этом величина подтравливания в некоторых случаях равна глубине травления. При ПТ показатель анизотропии обычно не превышает 2 - 4, что ограничивает предельное разрешение процесса на уровне 1.0—0.7 мкм. При требовании прецизионного травления плазменное травление может быть применимо, пока отношение ширины линии к толщине слоя превышает 5:1. Наличие анизотропии при плазменном травлении обусловлено природой пограничного слоя между плазмой и поверхностью обрабатываемого материала. Его природа такова, что заряженные частицы в нем вследствие разности потенциалов между поверхностью и плазмой движутся по траекториям, перпендикулярным поверхности материала. Но все же основную роль в плазменном травлении играют незаряженные активные частицы (ионы и электроны только стимулируют их реакции), а они, вследствие хаотичности движения, и вызывают подтравливание под маскирующий слой. Увеличение анизотропии, и, следовательно, разрешения плазменного травления, возможно при снижении рабочего давления. При этом увеличивается длина свободного пробега активных частиц и при небольших размерах окон в маскирующем слое, сравнимых с его толщиной (примерно 0,5 мкм), вероятность попадания активных частиц на боковые стенки подвергаемых травлению элементов значительно снижается. Диапазон рабочих давлений при плазменном травлении определяется характеристиками используемого для возбуждения плазмы разряда. Наиболее перспективным в этом плане является СВЧ разряд, позволяющий проводить процесс при давлениях меньше 0.1 Па, однако при этом снижается скорость травления материалов.
В настоящее время при изготовлении ИМС и полупроводниковых приборов ПТ применяется для многих материалов, к числу которых в первую очередь относятся кремний и его соединения, молибден, титан, тантал, вольфрам и др. С точки зрения влияния на обрабатываемые структуры при ПТ могут проявляться следующие особенности:
- Увеличение шероховатости обрабатываемой поверхности, которое может быть связано, во-первых, с загрязнениями (выделение твердых продуктов разложения исходных газов, распыление электродов и конструкционных материалов реактора а т.д.) и, во-вторых, с переосаждением основного травимого материала, которое проявляется, преимущественно, при высоких скоростях травления. Для устранения первой причины необходимо правильно подбирать рабочие среды, использовать химически инертные по отношению к плазмообразующему газу конструкционные материалы реакторов, по возможности снижать потенциалы электродов. Исключение переосаждения основного материала может быть достигнуто выбором оптимального соотношения между скоростью травления и потоком рабочего газа.
- Появление радиационных дефектов, связанное с ионной бомбардировкой и ультрафиолетовым облучением. При плазмохимическом травлении радиационные дефекты, как правило, незначительны и, в случае необходимости, могут быть легко устранены отжигом при 400 - 500 0С.
Эффективным методом очистки поверхности является ионное травление, или бомбардировка поверхности в высоком вакууме ионами с энергией 102 – 105 эВ. Реализация этого метода основана на организации ионных потоков, которые, попадая на мишень, распыляют поверхностный слой, удаляя тем самым адсорбированные атомы и окисные пленки. По тому, как организуется поток ионов, различают несколько способов ионного травления.
Тлеющий разряд. Процесс распыления в этом случае наблюдается на катоде и называется «катодным распылением». Давление газа, ионы которого используются для травления, составляет (10 – 103) Па, т.е. длина свободного пробега молекул газа мала по сравнению с характерным размером разрядного объема. Поэтому возможны многократные столкновения между газовыми частицами в разряде, что в свою очередь может привести к образованию многократных ионов и к ионизации распыленных частиц. По этой причине невозможно произвести количественную оценку эффекта распыления, т.е. вычислить коэффициент распыления S (отношение количества выбитых атомов к числу бомбардирующих ионов). Поскольку в разряде ионы имеют различную энергию, невозможно определить зависимость S от энергии падающих ионов. Удаление материала с поверхности происходит по одному или по всем трем основным механизмам в зависимости от природы поверхности, природы и энергии ионов и т.д. Первый механизм наиболее очевиден – это физическое распыление, т.е. удаление с поверхности атомов вследствие передачи импульса от ионов высокой энергии атомам или молекулам, находящимся на поверхности. Второй – известен как химическое распыление (плазменное травление). В действие этого механизма вовлечена химическая реакция между падающими ионами газа и находящимися на поверхности атомами с образованием летучего соединения, которое удаляется в процессе откачки. Примером такой реакции является удаление углерода или органических соединений с поверхности в кислородном разряде путем образования CO, CO2, OH и т.д. Третий механизм – это простая термическая десорбция вследствие возрастания температуры поверхности при ионной бомбардировке.
Газовый разряд низкого давления в магнитном поле. Чтобы уменьшить эффект многократного столкновения в газовой плазме и исключить ионизацию распыленных атомов, применяют газовый разряд при давлении (1 – 10-1 Па). Поскольку при этом длина свободного пробега молекул газа примерно равна размеру разрядного промежутка или больше, то вследствие этого уменьшается вероятность ионизации газа электронами. Для создания плотного потока ионов при бомбардировке, предотвращения процессов многократной перезарядки разрядный промежуток помещают в постоянное магнитное поле, параллельное направлению разряда. Энергия ионов в этом случае должна быть достаточно высока, поскольку в магнитном поле их траектория может измениться, и ионы будут попадать на мишень неравномерно.
Метод плазмы. Плазма низкого давления (10-1 – 10-2 Па) получается с помощью ртутного дугового разряда между анодом и жидким ртутным катодом. Разряд стабилизируется и поддерживается с помощью вспомогательного анода. Сетка, помещенная между анодом и катодом, позволяет изменять плотность плазмы вблизи анода. В этом случае вокруг мишени образуется ионное облако и происходит травление. Кинетическая энергия ионов определяется напряжением между мишенью и анодом.
Метод ионных пучков. Этот метод основан на применении специальных устройств, называемых ионными пушками. В ионной пушке, которая находится в вакууме, ионизируются молекулы газа (например, аргона), ионы ускоряются электростатическим полем, коллимируются в пучок известной геометрии и направляются на очищаемую поверхность. Для расчета скорости распыления вещества бомбардируемой поверхности под действием ионов используется коэффициент распыления [2,8]. Этот коэффициент зависит от массы иона, массы атома поверхности, энергии ионов, угла их падения. Если ток I падающих ионов и время облучения мишени t мишени известны, то коэффициент распыления S (атом/ион) может быть определен из соотношения
S = 26,6*∆m/A*I*t
где ∆m - потеря массы вещества мишени, выражается в микрограммах, I – в микроамперах, t - в часах, A - массовое число атома мишени (кг/моль). Поскольку глубина проникновения ионов в процессе травления поверхности значительна (ионы Ar+ при Eк = 103 эВ проникают в медный образец на глубину ~ 1 нм), то обычно после ионной бомбардировки проводят отжиг образца с целью удаления имплантированных атомов обратной диффузией. Ионная очистка и отжиг поверхности производится в атмосфере остаточных газов с давлением ниже 10-7 Па для избежания повторного загрязнения поверхности хемосорбентами. Другой недостаток метода ионных пучков – это появление физических неоднородностей на поверхности при бомбардировке. Например, бомбардировка монокристаллического слоя золота ионами с энергией Eк = 12 кэВ превращает его в поликристаллический слой. А при бомбардировке монокристаллического образца серебра ионами аргона эффект разрушения кристаллической структуры наблюдается при энергиях от 12 эВ до 4 кэВ. При этом происходит разбиение кристалла на зоны размером ~ 10 нм различной кристаллографической ориентации. Устранение некоторых видов физической неоднородности, вызванной ионной бомбардировкой, может быть обеспечено термическим отжигом образца в вакууме.
источники ионов с холодным катодом и устройства на их основе, реализующие процессы ионной очистки и полировки поверхности, ионного ассистирования процессов магнетронного осаждения, а также ионно-лучевого нанесения пленочных покрытий (в том числе многослойных) распылением соответствующих мишеней. Инструментом обработки служат направленные потоки ионов инертных и химически активных газов, ускоренных до энергии от 300 до 2500 эВ. Принцип действия ионных источников основан на формировании высокоплотной плазмы ионизацией рабочего газа в тлеющем разряде в скрещенных электрическом и магнитном полях, отборе ионов с границы плазмы и ускорении их электрическим полем (принятое в литературе название – «ускоритель с анодным слоем»).
.
Типовые схемы ионно-лучевой обработки поверхностей и объектов в вакууме:
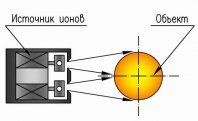
| Ионно-лучевая обработка (очистка, травление) |

| Ионно-лучевое распыление материалов |
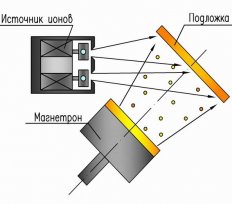
| Ионно-лучевая обработка, сопровождающая процесс нанесения покрытия (ионное ассистирование) |

| Нанесение многокомпонентных покрытий |

| Двухсторонняя обработка объектов |
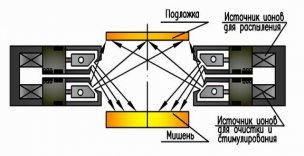
| Схема комбинированого источника ионов (ионно-лучевая очистка, распыление, ассистирование) |
1.Плазмохимическое травление неорганических материалов.
Механизмы плазмохимического травления материалов интересовали многих ученых и технологов , но до недавнего времени исследование механизмов состояло в изучении зависимостей скоростей травления материалов от состава и внешних параметров плазмы. Развитие методов диагностики параметров плазмы (зонды, спектроскопия, в том числе и лазерная), а также применение современных методов анализа поверхности - ренгеноэлектронная спектроскопия, электронная микроскопия, спектроскопия вторичных ионов - позволило подойти как к исследованию механизмов химических реакций в плазме галогенсодержащих газов с целью определения потоков нейтральных частиц на поверхность травимого материала, так и к разработке количественных методов исследования механизмов травления материалов. По существу появилась возможность количественной характеристики состава и энергий частиц плазмы, бомбардирующих поверхность материалов, скоростей химических реакций травления и состава продуктов в газовой фазе и твердом теле. Существенную помощь оказали и результаты исследования химических реакций в модельных системах - при взаимодействии нейтральных атомов и молекул с поверхностью материалов, при ионном травлении (ИТ), при ионно-стимулированном травлении материалов галогенами (ИТ,РИТ). Эти исследования выявили основные стадии процессов: образование активных частиц - в первую очередь атомов галогенов, кислорода и галогенсодержащих радикалов в плазме, адсорбцию их на поверхности материала, диффузию вглубь материала под поверхностный слой атомов, химические реакции в твёрдом теле с образованием летучих галогенидов, оксигалогенидов материалов и окислов ( в случае травления полимеров), десорбцию летучих продуктов с поверхности материала и распыление нелетучих продуктов. Так, количественные данные по концентрациям атомарного фтора в плазме различных разрядов позволили установить факты как значительного увеличения скорости травления кремния и металлов, так и заметного снижения по сравнению со скоростями травления в послесвечении разрядов, то есть в отсутствие бомбардировки заряженными частицами при одинаковых потоках атомов фтора на поверхность. Например, для кремния увеличение достигает свыше двух порядков величины , а снижение наблюдается при больших концентрациях атомов фтора и больших потоках и энергиях заряженных частиц и достигает от нескольких десятков процентов до нескольких раз.
Увеличение скорости травления в плазме естественно связать с влиянием потока заряженных частиц на поверхность, как это наблюдается при ионно-стимулированном травлении, когда поверхность бомбардируется одновременно ионами и нейтральными атомами и молекулами фтора, а также возможным вкладом насыщенных радикалов в травление. Детальные исследования в плазме подтвердили эти выводы. Более того, наблюдалось еще дополнительное влияние величины электрического потенциала поверхности относительно плазмы . Увеличение ионного потока за счёт наложения на поверхность кремния масок из SiO2 и алюминия не влияет на скорость травления при прочих равных условиях. Вместе с тем увеличение величины отрицательного потенциала поверхности относительно потенциала плазмы приводит к увеличению скорости травления даже при сравнительно высоких давлениях газа 20 - 80 Па. При уменьшении давления эффект становится более ярко выраженным и увеличивается также за счёт увеличения энергии падающих ионов вследствие ускорения их в приповерхностном слое плазмы. Эффект поля объясняется непосредственным его влиянием на адсорбцию нейтральных частиц поверхностью. Аналогичные эффекты поля наблюдаются, например, при гетерогенном катализе химических реакций.
Кроме того, влияние на увеличение скорости травления кремния во фторсодержащей плазме может оказывать очистка его поверхности за счет ионного распыления поверхностного слоя нелетучих продуктов, образующихся, например, при окислении поверхности кислородом, добавляемым в рабочий газ для улучшения некоторых характеристик процесса, или являющимся малой примесью основного плазмообразующего газа.
Уменьшение скорости травления в плазме по сравнению со скоростью травления в послесвечении ( при бомбардировке одними атомами фтора) связано с различными факторами, приводящими к пассивации поверхности - за счёт бомбардировки травимой поверхности ненасыщенными радикалами, приводящими к осаждению полимерного слоя, препятствующего травлению, за счёт переосаждения нелетучих продуктов, распыляемых вследствие ионной бомбардировки поверхности стенок реакторов и электродов, что приводит даже к зависимости скорости травления от времени . Детальные исследования состава поверхности образцов после травления обнаружили в этом случае нелетучие продукты распыления материалов стенок реактора - фториды щелочных металлов.
Наглядное подтверждение сильного влияния материала поверхности на скорости и вероятности травления материалов в плазме получено при изменении материалов электродов, на которых располагаются, как правило, обрабатываемые образцы (табл. 1). Как следует из данных этой таблицы, вероятность травления кремния в послесвечении разряда с электродами, покрытыми кремнием, составляет 5x10-4 и уменьшается при покрытии электродов алюминием, оксидом алюминия и тефлоном. В плазме разряда вероятность травления увеличивается в 140 - 540 раз. На алюминиевых электродах вероятность хотя и увеличивается за счет одновременной бомбардировки поверхности образца атомами фтора и ионами, но остается минимальной. При покрытии из оксида железа наблюдается монотонный спад вероятности травления со временем экспозиции. В обоих случаях на поверхности образцов после травления обнаружены атомы материала покрытия электродов - алюминия и железа. Поверхность образцов оказалась абсолютно чистой после травления в плазме с электродами, покрытыми кремнием и вольфрамом. Их фториды летучи и не переосаждаются на образцах. Более того, поверхность электродов является в этом случае геттером, абсорбирующим все примеси, способные пассивировать поверхность травимых материалов, сводя к минимуму их влияние. Вероятность травления в этих случаях максимальна и превышает даже максимальное значение (g ~ 0,1), полученное в послесвечении СВЧ разряда при минимальном давлении < 10 Па, при котором окисление образцов кислородом практически не зарегистрировано. Эти результаты подтверждают роль окисления в пассивации поверхностей травимых иатериалов. Аналогичное увеличение вероятности травления ( в 10 раз) наблюдалось и для сплава WTi (5:1) при покрытии алюминиевых электродов вольфрамом.
Более сложное влияние, различное для разных материалов, оказывает одновременная бомбардировка поверхности заряженными и различными нейтральными частицами. Например, одновременная бомбардировка атомами фтора и кислорода поверхности кремния и тантала приводит к снижению вероятности травления за счёт окисления поверхности, регистрируемого после экспозиции образцов в плазме. В то же время в случае вольфрама вероятность травления при малых отношениях потоков атомов кислорода и фтора также снижается, но при увеличении этого отношения вновь увеличивается. Это объясняется тем, что образующиеся оксифториды вольфрама являются летучими, так же как и фториды, и не пассивируют поверхность, а десорбируясь, ускоряют травление.
Результаты исследования механизмов травления ряда основных неорганических материалов, используемых в микроэлектронике, включая определение типов частиц, активных в травлении и пассивации поверхности, состава продуктов реакций в газовой фазе и твердом теле, влияния бомбардировки заряженными частицами и наличие анизотропии плазмохимического травления этих неорганических материалов обобщены в таблице 2.
Кремний.
Основные частицы, активные в травлении кремния - атомы фтора и радикалы SF5 (вклад последних в скорость травления составляет около 30%). Скорость травления при всех условиях и составах плазмы прямо пропорциональна концентрациям атомов фтора при прочих равных условиях и увеличивается с ростом потока ионов и разности потенциалов поверхности и плазмы при одинаковых концентрациях атомов. При низких давлениях и частоте поля, когда потенциал смещения образца относительно плазмы велик и велики энергии ионов (~ 100 эВ) скорость травления пропорциональна потоку ионов, как это отмечалось и при ионно-стимулированном травлении. Однако в плазме этот эффект вуалируется другими - переосаждением распыляемых ионами материалов электродов и стенок на поверхность образцов, пассивирующих ее и снижающих скорость травления. Такое же влияние оказывает окисление
поверхности кремния атомами, образующимися за счет диссоциации молекул кислорода (из-за малой неконтролируемой примеси в плазмообразующем газе, натекания атмосферы или контролируемых добавок). Основной продукт травления в газовой фазе SiF4 (насыщенный фторид), испаряющийся с поверхности, и SiF2 , имеющий повышенные энергии и десорбирующийся вследствие ионной бомбардировки. Пассивация поверхности за счет перечисленных выше частиц, а также атомов хлора в хлорсодержащей плазме, обеспечивает анизотропию травления вследствие ионной бомбардировки, увеличивающуюся по мере увеличения энергии ионов (низкое давление, низкая частота поля, наложение дополнительного смещения потенциалов от независимого источника или самосмещение). Однако по мере увеличения анизотропии увеличивается и опасность ухудшения качества поверхности после травления - нарушенная структура, состав, встроенный поверхностный заряд и др.
Вследствие высокой летучести SiF4 толщина фторированного слоя на поверхности травления мала (~ 1 нм) и состоит из ненасыщенных фторидов SiFx (х = 1 - 3), что свидетельствует о последовательном протекании реакций фторирования за счет присоединения атомов фтора.
Скорости травления увеличиваются по мере увеличения давления газа и мощности разряда. При больших площадях поверхности экспонируемых образцов наблюдается изменение состава плазмы за счет больших потоков продуктов, а также обеднения плазмы активными частицами. Это приводит к так называемому эффекту большой загрузки - снижению скорости травления с увеличением площади образцов.
В хлорсодержащей плазме, как и при ионно-стимулированном травлении, травление происходит только за счет ионной бомбардировки и наблюдается высокая анизотропия при низких скоростях травления. При использовании фтор-хлорсодержащей плазмы анизотропия за счет пассивации хлором сохраняется, а скорость травления увеличивается за счет бомбардировки атомарным фтором. Скорость травления легированного кремния зависит также от степени и типа его легирования.
Вольфрам.
Закономерности травления вольфрама аналогичны описанным выше для кремния, что обусловлено высокой летучестью насыщенного фторида (WF6) при комнатных температурах. Однако влияние окисления проявляется аналогично только при малых концентрациях кислорода в плазме. При этом возможна и анизотропия травления, но она выражена слабее. При повышении же концентрации кислорода вероятность травления возрастает, что обусловлено летучестью оксифторида вольфрама, и анизотропия также исчезает.
Молибден.
Механизмы травления молибдена также, в основном, аналогичны механизмам травления кремния. Отличия связаны с более высокой температурой кипения насыщенного фторида, что приводит к более низким вероятностям при комнатной температуре. С повышением температуры поверхности образцов вероятность травления увеличивается и различия уменьшаются.
Тантал.
Насыщенный фторид тантала плавится и кипит при температурах значительно выше комнатной . Поэтому вероятности и скорости травления его во фторсодержащей плазме при комнатной температуре значительно ниже, чем кремния. При этом на поверхности образуется достаточно толстая пленка фторида, а скорость травления сильно зависит от температуры и ионного потока (пропрционально последнему, как при ионо-стимулированных процессах). Атомы кислорода пассивируют поверхность, однако этот эффект слабее, чем для кремния. Это может быть связано с более высокой летучестью оксифторида тантала, хотя прямых данных об этом нет или, скорее всего, это - кажущийся эффект, связанный с другим механизмом десорбции продуктов - преимущественно ионным распылением.
Титан.
Во фторсодержащей плазме скорость травления мала вследствие малой летучести продуктов и ограничивается чисто ионным распылением образующейся пленки фторидов. Электронная бомбардировка ускоряет фторирование. Соответственно велика анизотропия травления. Плазмохимическое травление титана наблюдается в хлорсодержащей плазме вследствие более высокой летучести тетрахлорида титана (низкая температура травления). Однако в этом случае насыщенного хлорида в газовой фазе не обнаружено. По-видимому, летучими являются продукты TiFyClx. На поверхности наблюдаются большие концентрации фтора, связанные с взаимодействием фторсодержащих радикалов. Активными частицами в травлении являются не только атомы, но и молекулы хлора, и возможно, интергалогена FСl.
При высоких температурах (> 450 K) ионная бомбардировка не ускоряет травление, при низких (T < 325 K) наблюдается явное стимулирование травления ионами, а электроны ускоряют рост фторидной пленки. При высоких температурах это проявляется в повышении скорости травления.
Сплав WТi (5:1).
Механизм травления этого сплава интересен тем, что один из его компонентов имеет нелетучие фториды или хлориды при низких температурах. Во фторсодержащей плазме активными частицами в травлении являются радикалы SF5 и атомы фтора. Вследствие разной скорости травления фтором компонентов сплава на Аррениусовских зависимостях скорости травления от температуры наблюдается излом при температурах около 350 К. Эта температура ниже температуры плавления фторида титана, но выше соответствующей температуры плавления фторида вольфрама. Но фторид преобладающего компонента - вольфрама вовлекает в травление и титан, так как выше этой температуры сплав травится как единый материал и обогащения титаном на поверхности после травления не происходит. В то же время при Т < 350 К на поверхности наблюдается обогащение титаном и увеличивается энергия активации и соответственно снижается скорость травления.
Во фтор-хлорсодержащей плазме скорость травления сплава TiW повышается, но остается существенно ниже по сравнению со скоростью травления титана и сплава во фторсодержащей плазме, хотя при низких температурах (<320 К) они примерно одинаковы.
Алюминий.
Алюминий - один из основных металлов, используемых в металлизации при изготовлении БИС и СБИС - не имеет летучих галогенидов при комнатной температуре , за исключением димера Al2Cl6 , температура возгонки которого составляет 297 К. Поэтому травление пленок алюминия осуществляют в плазме хлорсодержащих газов и их смесей: Cl2, CCl4, BCl3, Cl2/CCl4 ; Cl2 /BCl 3 . Активными частицами, взаимодействующими с чистой поверхностью алюминия, являются атомы и молекулы хлора. Вероятности их реакций при комнатной температуре одинаковы и ионная бомбардировка их не ускоряет. Скорость травления не зависит от разности потенциалов между плазмой и поверхностью, мощности разряда. Основной продукт - Al2 Cl6. Травление изотропно. Однако поверхность пленок алюминия легко окисляется атмосферным воздухом. Поэтому в технологии, как правило, на практике травятся окисленные пленки. Окисленные пленки травятся преимущественно атомами хлора. Анизотропия травления достигается за счет добавок газов (CCl4, BCl3 ), генерирующих в плазме хлоруглеродные и бор-хлорные радикалы (CClx, x= 1-3; BClx, x=1-2). Они осаждаются на поверхности, пассивируя ее, и удаляются, так же как и окисленные слои, за счет ионной бомбардировки. Продукты травления переосаждаются на поверхности стенок реактора и частично на поверхности травимых образцов. Присутствие паров воды вследствие гигроскопичности хлоридов алюминия адсорбируются, вступая с ними в реакцию с образованием гидроксида алюминия. Это приводит к невоспроизводимости результатов и изменению свойств изделий вплоть до полного стравливания оставшихся участков пленки в БИС и СБИС во время хранения на атмосфере даже под защитным покрытием. Поэтому необходим строгий контроль за примесью паров воды, а также меры по очистке и пассивированию поверхности после травления и защите изделий, чтобы исключить последующий контакт алюминиевыхх слоев с атмосферой.
Медь.
Медные пленки травятся в хлорсодержащей плазме, поскольку хлориды более летучи, чем фториды. Частицами, активно взаимодействующими с поверхностью Cu(100) являются атомы и молекулы хлора, причем вероятность взаимодействия обоих частиц практически одинакова даже при комнатных температурах. Ионная бомбардировка не влияет на скорость процесса.
В результате взаимодействия на поверхности образуется слой хлорида меди СuCl , толщина которого при комнатной температуре пропорциональна времени экспозиции. Единственным летучим продуктом является тример Cu3 Cl3, температура сублимации которого составляет 423о С. Поэтому возможны два варианта организации процесса:
- экспозиция поверхности при комнатной температуре с последующим нагреванием до температуры выше начала сублимации тримера до полного удаления хлорированного слоя;
- экспозиция поверхности при температуре, превышающей температуру сублимации. В этом случае скорость травления может изменяться в широких пределах за счет вариации температуры. В обоих вариантах травление изотропно.
Индий, галлий.
Другие металлы III группы периодической системы - индий, галлий и их соединения с элементами V группы - фосфором, мышьяком также травят в хлорсодержащей плазме. Набор плазмообразующих газов в этом случае существенно больше Cl2 , CCl4, BCl3, Cl2 /BCl3, Br2, COCl2, CCl2F2, PCl3, HCl, CCl2F2/O2/Ar, CCl4/O2. Анизотропия травления достигается за счет использования фтора и кислорода, поскольку фториды и окислы этих элементов нелетучи и удаляются ионным распылением.
Хром.
Плазмохимическое травление пленок хрома осуществляется в плазме смесей хлорсодержащих газов с кислородом. Поскольку галогениды хрома нелетучи, единственным возможным продуктом травления в газовой фазе является летучий оксихлорид хрома СrO2Cl2 . Оксид хрома травится в хлорсодержащей плазме Сl2 + Ar, CCl4 + Ar cо значительно большей скоростью, чем хром, за счет содержавшегося в пленке кислорода, связанного с хромом. Это приводит к высокой селективности травления оксида относительно хрома.
Оксиды металлов.
Плазмохимическое травление оксидов металлов осуществляется только в тех случаях, когда образуются летучие оксифториды или оксихлориды (MoOF4, MoOClx (x=3-4), MoO2Cl2, WOF4, WOCl4, ReO2F2, ReOF4). При плазмохимическом травлении за счет взаимодействия с нейтральными частицами травление изотропно, но могут достигаться высокие селективности по отношению к металлам:
например S(TiO2/Ti) = 5; S(V2O5/V) = 8; (CrO2/Cr) > 20.
Травление остальных окислов в плазме происходит за счет ионного распыления (ИТ или РИТ), поэтому осуществляется при низких давлениях (Р<10Па) и больших потенциалах поверхности относительно плазмы (низкая частота электромагнитного поля f < ~ 100 кГц, автоматическое смещение или подача электрического потенциала от дополнительного источника). При этом возможно достижение анизотропии травления, но селективность снижается вследствие слабой зависимости вероятности травления ионами от массы.
Оксиды кремния.
Травление двуокиси кремния (SiO2) осуществляется во фторсодержащей плазме атомами фтора и фторсодержащими радикалами ( CFx, SF5 и др.). При этом продуктами в газовой фазе являются SiF4 и молекулы СО, SO, образующиеся путем окисления СFx и SF5 радикалов кислородом, содержащимся в материале. Поэтому адсорбции радикалов и пассивирования поверхности не происходит.
Скорость травления двуокиси во фторсодержащей плазме меньше скорости травления непассивированного кремния, поэтому, как правило, наблюдается высокая селективность травления кремния по отношению к SiO2. В случае пассивации поверхности кремния за счет осаждения полимерной пленки (например, в плазме С2F4, C3F4, ц-С4F8,C3F8) возможна полная остановка травления кремния. Тогда возможно достижение абсолютной обратной селективности - травления SiO2 к Si, так как пленка на поверхности диоксида не образуется. Повышение селективности травления диоксида к кремнию возможно и при пассивации кислородом, поскольку в этом случае атомарный кислород окисляет поверхность кремния до SiO, скорость травления которого, по крайней мере, на порядок меньше, чем SiO2, и S (SiO2/Si) @ 20 - 30. При высокой селективности травления диоксида оно становится и анизотропным, так как ионная бомбардировка ускоряет травление диоксида.
Моноксид кремния и кристаллический кварц можно травить, в основном, путем преимущественно ионной бомбардировки - при больших потоках и энергиях падающих ионов в режиме РИТ.
Нитрид кремния.
Пленки нитрида кремния используются при изготовлении БИС и СБИС в качестве защитных слоев, в том числе и от радиационных повреждений. Они так же, как и диоксид кремния, травятся во фторсодержащей плазме атомами, фторсодержащими радикалами с выделением SiF4 и N2 в газовую фазу. Скорость травления, как правило, меньше, чем кремния, и S (Si/Si3N4) @ 8 - 10. Положительное влияние на скорость травления нитрида оказывают добавки в плазмообразующий газ (CF4, C2F6, C3F8 ) водорода и углеводородов (CH4, C2H2, C2H4 ), приводящие к ускоренному образованию легколетучего продукта NH3. При этом скорость травления нитрида резко увеличивается, а кремния уменьшаетя за счет образования полимерных пленок. В результате наблюдается обратная селективность - S(Si3N4/Si) = 35 - 100.
2. Плазмохимическое травление органических материалов.
Полимерные пленки широко используются в производстве изделий в микроэлектронике в качестве фоторезистов и резистивных слоев для электронной и рентгеновской литографии, для защитных покрытий готовых микросхем, а также в качестве вспомогательных слоев - планаризации рельефной поверхности перед нанесением металлических слоев и др. Поэтому сухое или плазмохимическое травление полимерных пленок представляет весьма важный элемент технологии.
Как правило, органические материалы травятся в кислородсодержащей плазме. Основными активными частицами являются атомы кислорода, а десорбируемыми продуктами деструкции оксиды углерода - СО, СО2, водород - Н2, Н2О и радикалы ОН (при комнатной температуре), которые, взаимодействуя с водородом в объеме плазмы или вблизи поверхности, превращаются в пары воды. Для широкого круга полимерных фоторезистов скорость травления в кислородной плазме при одинаковых условиях меняется в небольших пределах - несколько десятков процентов. Энергия активации травления в большинстве случаев варьируется от 4 до 15 ккал/моль и зависит от параметров плазмы, а также состава и структуры полимера.
Фторсодержашие и полностью фтрорированные полимеры травятся со скоростями на порядок меньшими, чем углеводородные, и используются для повышения стойкости масок. Предварительная термообработка или ионная бомбардировка полимерных резистов может приводить к сшивкам полимерных цепей, что увеличивает стойкость полимеров в кислородсодержащей плазме. Этот эффект используется для создания негативных фоторезистов. В некоторых случаях предварительное облучение полимеров может приводить к структурным изменениям (обрывам цепей, боковых групп, образованию сшивок и т.п.), увеличивающим скорость травления, и используется для создания позитивных резистов.
Скорости травления почти всех исследованных полимеров увеличиваются при добавках в кислородсодержащую плазму фторуглеродных газов в первую очередь за счет повышения скорости генерации атомов кислорода. С другой стороны, генерация атомарного фтора и фторирование углеродных атомов, в особенности боковых групп, приводят к дополнительному их отрыву. Остающиеся свободные связи на поверхности быстрее взаимодействуют с атомарным кислородом.
3. Плазмохимическая полимеризация и ее роль в
плазмохимическом травлении материалов.
Как было показано в предыдущем разделе, плазмохимическая полимеризация на поверхности экспонируемых образцов играет важную роль в создании высокоселективных и высоко анизотропных процессов травления. Для оптимизации этих процессов необходимо знать механизмы плазмохимической полимеризации и согласовать ее роль с ролью активных частиц в травлении материалов. Для процессов травления важны механизмы полимеризации в галогенсодержащей, и в частности, во фторсодержащей плазме.
Значительный прогресс в изучении механизмов полимеризации во фторуглеродной плазме достигнут в результате разработки методов контроля потоков и энергий частиц, падающих на поверхность образцов.
Для регистрации потоков заряженных частиц используются различные варианты зондовых методов - тонкого зонда Ленгмюра, невозмущающего плазму, плоского зонда и их комбинации. Для регистрации нейтральных частиц - атомов и радикалов используются спектроскопические методы, наиболее разработанные для галогенуглеродной плазмы. Привлекаются данные о механизмах и скоростях газофазных реакций для определения потоков различных частиц на поверхности растущих полимерных плёнок.
Скорость роста полимерной плёнки во всех исследованных случаях существенно зависит от потока ионов при неизменных прочих потоках частиц (радикалов, УФ-квантов, стабильных ненасыщенных соединений). Встраивание ионов, как правило, не даёт значительного вклада в рост плёнки. В случае фторорганических соединений (перфторциклобутана) скорость роста полимера увеличивается и при увеличении электронной бомбардировки поверхности. Однако, для роста полимера необходима бомбардировка нейтральными частицами, а именно различными и особенно тяжелыми ненасыщенными радикалами. Наиболее приемлемой для объяснения полученных данных в углеводородной и фторуглеродной плазме оказалась активационно-рекомбинационная модель. Согласно этой модели, ионная бомбардировка поверхности или ион-электронная рекомбинация на поверхности приводят к созданию на ней свободных центров роста - ненасыщенных валентностей, к которым присоединяются радикалы, имеющие от одной до нескольких свободных валентностей. Гибель свободных центров может происходить в результате присоединения атомов водорода или галогена, в частности, фтора, а также вследствие взаимной рекомбинации центров. Экспериментально показано, что скорость полимеризации во всех исследованных случаях сильно падает по мере увеличения температуры поверхности. Объяснение этого факта в активационно-рекомбинационной модели вызывает наибольшие затруднения. Привлекаются соображения о сложной структуре поверхности, в результате чего с увеличением температуры увеличивается скорость взаимной рекомбинации свободных центров, а также об ускорении с ростом температуры взаимной рекомбинации поверхности центров и десорбции пришедших радикалов до их полной термолизации после присоединения к центрам роста. Кроме того, эксперименты показали, что ионная бомбардировка приводит не только к ускорению роста. В случае галогенуглеродов при больших энергиях ионов в бедных смесях фторуглеродов с инертными газами наблюдается травление полимера в результате ионной бомбардировки, приводящее к прекращению роста и даже уменьшению массы ранее полученного полимера. Этот процесс также зависит от температуры поверхности. Скорости отдельных элементарных актов сложного процесса, которым является плазмохимическая полимеризация, зависят от температуры поверхности и её электрического потенциала. Релаксационные исследования подтвердили активационную модель для ряда иследованных углеводородных и галогенуглеродных газов. При этом показано, что время жизни активных центров на поверхности достигает нескольких секунд. В первоначальной модели предполагалось, что образование активных центров является результатом выделения энергии только при рекомбинации ионов на поверхности. Однако в дальнейшем было показано, что скорость их образования в галогенсодержащей плазме зависит от кинетической энергии ионов.
Активационно-рекомбинационная модель полимеризации подтверждена путём математического моделирования газофазных и гетерофазных реакций в плазме смесей метана с инертными газами , а также в галогенуглеродной плазме (С2F4, C3F6, ц-С4F8). Использование результатов детального экспериментального исследования механизмов газофазных реакций и закономерностей процесса полимеризации в плазме ц- С4F8, а также математического моделирования этих процессов показало, что первичный распад фторуглеродов происходит в результате однократных столкновений электронов с молекулами по ряду паралельных каналов, включающих образование стабильных ненасыщенных молекул, моно- и бирадикалов и атомарного фтора. Атомарный фтор вступает в быстрые реакции диспропорционирования с ненасыщенными фторуглеродами, разлагая их на более лёгкие радикалы, что значительно снижает его концентрацию и гибель свободных центров на поверхности. Вторичные реакции радикалов (рекомбинации, диспропорционирования с участием бирадикалов) приводят к образованию более тяжелых ненасыщенных стабильных продуктов, концентрация которых проходит через максимум в зависимости от времени пребывания газа в плазме вследствие диссоциации электронным ударом и диспропорционирования. Вторичные реакции монорадикалов приводят к образованию насыщенных фторуглеродов, не участвующих в полимеризации, концентрация которых растёт пропорционально времени пребывания частиц в плазме (t р) . Вследствие вторичных реакций с участием радикалов в плазме синтезируются более тяжелые молекулы и радикалы (СnFm, n  5-11), чем исходные молекулы . Основной вклад в скорость роста полимерной плёнки при t р > 50 мс на поверхности даёт встраивание нейтральных тяжёлых радикалов С4 - С8 на активные поверхностные центры . Вклад более лёгких радикалов увеличивается по мере уменьшения времени пребывания частиц в плазме (t р < 20 мс) . Активные центры на поверхности образуются за счёт ионной и электронной бомбардировки поверхности и гибнут при присоединении атомов фтора и монорадикалов. Процесс полимеризации продолжается и при прекращении разряда (при импульсной модуляции тока), что обеспечивается вкладом бирадикалов. Большой вклад бирадикалов, в первую очередь СF2 и С2F4, в модулированной плазме приводит к резкому изменению структуры и состава полимерных плёнок, которые приближаются к составу и структуре тефлона. Этому способствует и отсутствие ионной бомбардировки поверхности в паузе тока. Тогда как при больших временах пребывания, характерных для стационарной плазмы, используемой в травлении материалов, полимер является сильно сшитым, а состав соответствует С : Н = 1 : 1,2 - 1 : 1,8.
5-11), чем исходные молекулы . Основной вклад в скорость роста полимерной плёнки при t р > 50 мс на поверхности даёт встраивание нейтральных тяжёлых радикалов С4 - С8 на активные поверхностные центры . Вклад более лёгких радикалов увеличивается по мере уменьшения времени пребывания частиц в плазме (t р < 20 мс) . Активные центры на поверхности образуются за счёт ионной и электронной бомбардировки поверхности и гибнут при присоединении атомов фтора и монорадикалов. Процесс полимеризации продолжается и при прекращении разряда (при импульсной модуляции тока), что обеспечивается вкладом бирадикалов. Большой вклад бирадикалов, в первую очередь СF2 и С2F4, в модулированной плазме приводит к резкому изменению структуры и состава полимерных плёнок, которые приближаются к составу и структуре тефлона. Этому способствует и отсутствие ионной бомбардировки поверхности в паузе тока. Тогда как при больших временах пребывания, характерных для стационарной плазмы, используемой в травлении материалов, полимер является сильно сшитым, а состав соответствует С : Н = 1 : 1,2 - 1 : 1,8.
Описанные выше закономерности и механизм полимеризации во фторсодержащей плазме в общих чертах аналогичны описанным ранее для углеводородной плазмы. Основываясь на аналогиях в поведении углеводородов и фторуглеродов можно считать, что они будут проявляться и в случае хлоруглеродной плазмы.
Во всех случаях травления материалов в плазме фтор- и хлоруглеродных газов и их смесей с углеводородами описанные закономерности и механизмы полимеризации можно использовать для оптимизации процессов травления, в частности, в достижении анизотропии траления.
Прежде всего, состав плазмы должен выбираться из тех соображений, чтобы скорости осаждения полимерных пленок на травимых материалах превышали скорости их травления в условиях плазмы при отсутствии ионной бомбардировки, но были меньше скорости ионно-стимулированного травления осаждаемого полимера. В этом случае на боковых поверхностях рельефа, не подверженных ионной бомбардировке, будет осаждаться полимерная пленка, пассивирующая поверхность и блокирующая травление материала подложки. На поверхностях, бомбардируемых ионами (дно рельефа), падающими по линиям электрического поля - перпендикулярно поверхности образцов, пленка осаждаться не будет и скорость травления будет соответственно выше. Таким образом, будет осуществляться направленное травление поверхности в направлении, перпендикулярном ей при отсутствии бокового подтрава материала под маску, т.е. высокоанизотропное травление.
После достижения требуемой геометрии рельефа в случаях анизотропного плазмохимического травления в полимеризующейся плазме необходимо вводить операцию изотропного травления полимерной пленки с целью удаления ее с боковых поверхностей и точного воспроизведения размеров и поверхностных свойств материалов.
Необходимо отметить, что общей особенностью протекания процессов травления неорганических соединений в плазме является образование на поверхности травимых материалов слоёв нелетучих продуктов (пассивация) в результате взаимодействия с углеродсодержащими радикалами (полимеризация) и с кислородом, а также в результате переосаждения на поверхности травимых материалов продуктов распыления материалов стенок и электродов ионной бомбардировкой. Эти нелетучие продукты удаляются только за счёт последующей ионной бомбардировки пассивированной поверхности, что и составляет основу для разработки анизотропных (направленных) процессов травления для создания элементов рельефа с отвесными стенками. Используется тот факт, что потоки ионов падают на поверхность по силовым линиям электромагнитных полей и при бомбардировке удаляют пассивирующие слои с горизонтальных участков поверхности, оставляя их там, куда бомбардирующиее ионы не попадают. Кроме того, выявлено, что различные материалы травятся неодинаково разными частицами, что составляет основу для изменения селективности травления разных слоёв материалов по отношению друг к другу с целью направленного формирования необходимых структур на поверхности. Ионная бомбардировка оказывает многостороннее воздействие на поверхность, ускоряя диффузию галогенов и кислорода вглубь материала, разрывая связи и ускоряя реакции в теле, распыляя нелетучие продукты. Результат существенно зависит от конкретной системы.
Поэтому в большинстве случаев травления неорганических материалов в плазме, особенно в случаях анизотропного и селективного травления, требуются дополнительные операции очистки поверхности, удаления дефектов структуры, вносимых в материалы в результате бомбардировки различными частицами плазмы (в том числе встроенный заряд, образование нарушенных слоев, внесение примесей и т.д.). Эти операции осуществляются различными способами, например, путем отжига материалов нагреванием вплоть до высоких температур (до 1000оС) в вакууме и в атмосферах различных газов.
В заключение необходимо отметить, что плазмохимические методы травления различных материалов в сочетании со стимулированными плазмой процессами осаждения различных слоев позволили создать полностью замкнутые сухие методы создания сложных изделий микроэлектроники - СБИС и сверхбыстродействующей схемы.
Этот комплекс методов уже используется и в других областях техники - при создании миниатюрных сенсоров - чувствительных приборов обнаружения примесей в газах и других средах, датчиков, микродвигателей, в электронике, электротехнике, микроинженерии. Области применения их непрерывно расширяются и этот процесс в ближайшее время будет протекать с ускорением.
Литература
Плазменная технология в производстве СБИС // Под ред. Айнспрукa Н. и Брауна Д. Пер. с англ. М.: Мир, 1987 ; Словецкий Д.И. Гетерогенные реакции в галогенсодержащей плазме // Химия плазмы. Под ред. Смирнова Б.М. М.: Энергоатомиздат. 1989. Вып.15. С.208-265; Словецкий Д.И. Плазмохимическая полимеризация фторуглеродов // Химия плазмы. Под ред. Смирнова Б.М. М.: Энергоатомиздат. 1990. Вып. 16. С.156-212 ; Словецкий Д.И. Механизмы химческих реакций в неравновесной плазме. М.: Наука. 1980.