 |
|
Физика преобразования энергии в диодном оптроне
Рассмотрение процессов преобразования энергии в оптроне требует учитывать квантовую природу света. Известно, что электромагнитное излучение может быть представлено в виде потока частиц - квантов (фотонов), энергия. каждого из которых определяется соотношением:
Eф = hn = hc / nl (2.1)
где h - постоянная Планка ;
с - скорость света в вакууме ;
n - показатель преломления полупроводника ;
n, l - частота колебаний и длина волны оптического излучения.
Если плотность потока квантов (т. е. число квантов, пролетающих через единицу площади в единицу времени) равна Nф, то полная удельная мощность излучения составит:
Pф = Nф * Eф (2.2)
и, как видно из (2.1), при заданном Nф она тем больше, чем короче длина волны излучения. Поскольку на практике заданной бывает Pф (энергетическая облученность фотоприемника), то представляется полезным следующее соотношение
Nф = Pф / Eф = 5 * 1015 l Pф (2.3)
где Nф, см-2 с-1; l, мкм; Pф, мВт/см.

Рис. 2. Энергетическая диаграмма прямозонного полупроводника (на примере тройного соединения GaAsP)
Механизм инжекционной люминесценции в светодиоде состоит из трех основных процессов: излучательная (и безызлучательная) рекомбинация в полупроводниках, инжекция избыточных неосновных носителей заряда в базу светодиода и вывод излучения из области генерации.
Рекомбинация носителей заряда в полупроводнике определяется, прежде всего, его зонной диаграммой, наличием и природой примесей и дефектов, степенью нарушения равновесного состояния. Основные материалы оптронных излучателей (GaAs и тройные соединения на его основе GaA1As и GaAsP) относятся к прямозонным полупроводникам, т.е. к таким, в которых разрешенными являются прямые оптические переходы зона-зона (рис. 2). Каждый акт рекомбинации носителя заряда по этой схеме сопровождается излучением кванта, длина волны которого в соответствии с законом сохранения энергии определяется соотношением:
lизл [мкм] = 1,23 / Eф [эB] (2.4)
Следует отметить, Что имеются и конкурирующие безызлучательные - механизмы рекомбинации. К числу важнейших из них относятся:
- Рекомбинация на глубоких центрах. Электрон может переходить в валентную зону не прямо, а через те или иные центры рекомбинации, образующие разрешенные энергетические уровни в запрещенной зоне (уровень Et на рисунке 2).
- Оже-рекомбинация (или ударная). При очень высоких концентрациях свободных носителей заряда в полупроводнике растет вероятность столкновения трех тел, энергия рекомбинирующей электронно-дырочной пары при этом отдается третьему свободному носителю в форме кинетической энергии, которую он постепенно растрачивает при соударениях с решеткой.

Pис. 3. Электрическая (a) и оптическая (b) модели светодиода. A - оптически "прозрачная" часть кристалла; B - активная часть кристалла; C -"непрозрачная" часть кристалла; D - омические контакты; E - область объемного заряда
Относительная роль различных механизмов рекомбинации описывается введением понятия внутреннего квантового выхода излучения hint, определяемого отношением вероятности излучательной рекомбинации к полной (излучательной и безызлучательной) вероятности рекомбинации (или, иначе, отношением числа генерированных квантов к числу инжектированных за то же время неосновных носителей заряда). Значение hint является важнейшей характеристикой материала, используемого в светодиоде; очевидно, что 0  hint
hint  100%.
100%.
Создание избыточной концентрации свободных носителей в активной (излучающей) области кристалла светодиода осуществляется путем инжекции их р-n-переходом, смещенным в прямом направлении.
"Полезной" компонентной тока, поддерживающей излучательную рекомбинацию в активной области диода, является ток электронов In (рис. 3,а), инжектируемых р-n-переходом. К "бесполезным" компонентам прямого тока относятся:
- Дырочная составляющая Ip, обусловленная инжекцией дырок в n-область и отражающая тот факт, что р - n-переходов с односторонней инжекцией не бывает, Доля этого тока тем меньше чем сильнее легирована n-область по сравнению с р-областью.
- Ток рекомбинации (безызлучательной) в области объемного заряда р - n-перехода Iрек. В полупроводниках с большой шириной запрещенной зоны при малых прямых смещениях доля этого тока может быть заметной.
- Туннельный ток Iтун , обусловленный "просачиванием" носителей заряда через потенциальный барьер. Ток переносится основными носителями и вклада в излучательную рекомбинацию не дает. Туннельный ток тем больше, чем уже р - n-переход, он заметен при сильной степени легирования базовой области и при больших прямых смещениях.
- Ток поверхностных утечек Iпов, обусловленный отличием свойств поверхности полупроводника от свойств объема и наличием тех или иных закорачивающих включений.
Эффективность р - n-перехода характеризуется коэффициентом инжекции:

| (2.5) |
Очевидно, что пределы возможного изменения g те же, что и у hint, т. е. 0  g
g  100%.
100%.
При выводе излучения из области генерации имеют место следующие виды потерь энергии (рис. 3, б):
- Потери на самопоглощение (лучи 1). Если длина волны генерируемых квантов в точности соответствует формуле (2.4), то она совпадает с "красной границей" поглощения (см. ниже), и такое излучение быстро поглощается в толще полупроводника (самопоглощение). В действительности, излучение в прямозонных полупроводниках идет не по приведенной выше идеальной, схеме. Поэтому длина волны генерируемых квантов несколько больше, чем по (2.4):
- Потери на полное внутреннее отражение (лучи 2). Известно, что при падении лучей света на границу раздела оптически плотной среды (полупроводник) с оптически менее плотной (воздух) для части этих лучей выполняется условие полного внутреннего отражения такие лучи, отразившиеся внутрь кристалла, в конечном счете, теряются за счет самопоглощения.
- Потери на обратное и торцевое излучение (луч 3 и 4).
Количественно эффективность вывода оптической энергии из кристалла характеризуется коэффициентом вывода Копт определяемым отношением мощности излучения, выходящего в нужном направлении, к мощности излучения, генерируемой внутри кристалла. Так же, как и для коэффициентов hint и g , всегда выполняется условие 0  Копт
Копт  100%.
100%.
g. Интегральным показателем излучательной способности светодиода является величина внешнего квантового выхода hext. Из сказанного ясно, что hext = hint g Копт.
Перейдем к приемному блоку. Принцип действия используемых в оптронах фотприемников основан на внутреннем фотоэффекте, заключающемся в отрыве электронов от атомов внутри тела под действием электромагнитного (оптического) излучения.
Кванты света, поглощаясь в кристалле, могут вызывать отрыв электронов от атомов, как самого полупроводника, так и примеси. В соответствии с этим говорят о собственном (беспримесном) и примесном поглощении (фотоэффекте). Поскольку концентрация примесных атомов мала, фотоэлектрические эффекты, основанные на собственном поглощении, всегда существеннее, чем основанные на примесном. Все используемые в оптронах фотоприемники "работают" на беспримесном фотоэффекте. Для того чтобы квант света вызывал отрыв электрона от атома, необходимо выполнение очевидных энергетических соотношений:
Eф1 = hn1  Ec - Ev (2.6)
Ec - Ev (2.6)
Eф2 = hn2  Ec - Et (2.7)
Ec - Et (2.7)
Таким образом, собственный фотоэффект может иметь место лишь при воздействии на полупроводник излучения с длиной волны, меньшей некоторого значения lгр:
lгр = hc / ( Ec - Ev)  1.23/ Eg (2.8)
1.23/ Eg (2.8)
Второе равенство в (2.8) справедливо, если lгр выражено в микрометрах, а ширина запрещенной зоны полупроводника Eg - в электроновольтах. Величину lгр называют длинноволновой или "красной" границей спектральной чувствительности материала.
Интенсивность протекания фотоэффекта (в той спектральной области, где он может существовать) зависит от квантового выхода, определяемого отношением числа генерированных пар электрон-дырка к числу поглощенных фотонов. Анализ экспериментальных зависимостей от показывает, что в интересной для оптронов спектральной области b = 1.
Образование свободных носителей заряда под действием облучения проявляется в полупроводнике в виде двух фотоэлектрических эффектов: фотопроводимости (возрастание проводимости образца при засветке) и фотовольтаического (возникновение фото-ЭДС на р - n-переходе или другом виде потенциального барьера в полупроводнике при освещении). Оба эффекта используются в практике конструирования фотоприемников; для оптронов предпочтительным и доминирующим является использование фото-ЭДС-эффекта.
Основные параметры и характеристики фотоприемников (безотносительно к физической природе и конструкции этих приборов) можно подразделить на несколько групп , К оптическим характеристикам относятся площадь фоточувствительной поверхности, материал, размеры и конфигурация оптического окна; максимальный и минимальный уровни мощности излучения. К электрооптическим - фоточувствительность, степень однородности распределения чувствительности по фотоприемной площадке; спектральная плотность чувствительности (зависимость параметра, характеризующего чувствительность, от длины волны); собственные шумы фотоприемника и их зависимость от уровня засветки и диапазона рабочих частот; разрешающее время (быстродействие); коэффициент качества (комбинированный показатель, позволяющий сопоставлять различные фотоприемники друг с другом); показатель линейности; динамический диапазон. Как элемент электрической цепи фотоприемник характеризуется, прежде всего, параметрами его эквивалентной схемы, требованиями к рабочим режимам, наличием (или отсутствием) встроенного механизма усиления, видом и формой выходного сигнала. Прочие характеристики: эксплуатационные, надежностные, габаритные, технологические - ничего специфически "фотоприемного" не содержат.
В зависимости от характера выходного сигнала (напряжение, ток) говорят о вольтовой или токовой фоточувствительности приемника S, измеряемых соответственно в В/Вт или А/Вт. Линейность (или нелинейность) фотоприемника определяется значением показателя степени n в уравнении, связывающем выходной сигнал с входным: Uвых( или Iвых) ~ Pф. При n  1 фотоприемник линеен; область значений Pф(от Pф max до Pф min), в которой это выполняется, определяет динамический диапазон линейности фотоприемника D , выражаемый обычно в децибелах: D = 10 lg (Pф max / Pф min).
1 фотоприемник линеен; область значений Pф(от Pф max до Pф min), в которой это выполняется, определяет динамический диапазон линейности фотоприемника D , выражаемый обычно в децибелах: D = 10 lg (Pф max / Pф min).
Важнейшим параметром фотоприемника, определяющим порог его чувствительности, является удельная обнаружительная способность D, измеряемая в Вт-1 м Гц1/2. При известном значении D порог чувствительности (минимальная фиксируемая мощность излучения) определяется как
Pф min =  / D (2.9)
/ D (2.9)
где А - площадь фоточувствительной площадки; Df- диапазон рабочих частот усилителя фотосигналов. Иными словами, параметр D играет роль коэффициента качества фотоприемника.
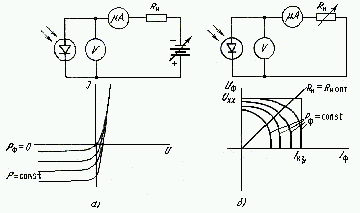
Рис. 4. Схемы измерения и семейства вольт-амперных характеристик в фотодиодном (а) и фотовентильном (б) режимах работы диода
В применении к оптронам не все перечисленные характеристики оказываются одинаково важными. Как правило, фотоприемники в оптронах работают при облученностях, очень далеких от пороговых, поэтому использование параметров Pф min и D оказывается практически бесполезным. Конструктивно фотоприемник в оптроне обычно, "утоплен" в иммерсионную. среду, соединяющую его с излучателем, поэтому знание оптических характеристик входного окна теряет смысл (как правило, специально такого окна нет). Не очень важно знать и распределение чувствительности по фоточувствительной площадке, так как интерес представляют интегральные эффекты.
Механизм работы фотоприемников, базирующихся на фотовольтаическом эффекте, рассмотрим на примере планарно-эпитаксиальных фотодиодов с р-n-переходом и с р-i-n-структурой, в которых можно выделить n+- подложку, базу n- или i-типа (слабая проводимость n-типа) и тонкий р+-слой. При работе в фотодиодном режиме (рис. 4,а) приложенное извне напряжение заставляет подвижные дырки и электроны уходить от р - n(р - i)-перехода; при этом картина распределения поля в кристалле оказывается резко различной для двух рассматриваемых структур.
Световое излучение, поглощаясь в базовой области диода, генерирует электронно-дырочные пары, которые диффундируют к р - n-переходу, разделяются им и вызывают появление дополнительного тока во внешней цепи. В р - i - n-диодах это разделение происходит в поле i-o6лaсти и вместо процесса диффузии имеет место дрейф носителей заряда под влиянием электрического поля. Каждая генерированная электронно-дырочная пара, прошедшая через р - n-переход, вызывает прохождение во внешней цепи заряда, равного заряду электрона. Чем больше облученность диода, тем больше фототок. Фототок протекает и при смещении диода в прямом направлении (рис. 4, а), однако уже при небольших напряжениях он оказывается намного меньше прямого тока, поэтому его выделение оказывается затруднительным.
Рабочей областью вольт-амперных характеристик фотодиода является III квадрант на рис. 4,а; соответственно этому в качестве важнейшего параметра выступает токовая чувствительность

| (2.10) |
Второе равенство в (2.10) получено в предположении линейной зависимости Iф = f(Pф), а третье - при условии пренебрежения темновым током (IT << IФ ), что для кремниевых фотодиодов обычно выполняется.
Если освещать фотодиод без приложения к нему внешнего смещения, то процесс разделения генерируемых электронов и дырок будет протекать благодаря действию собственного встроенного поля р - n-перехода. При этом дырки будут перетекать в р-область и частично компенсировать встроенное поле р - n-перехода. Создается некоторое новое равновесное (для данного значения: Pф) состояние, при котором на внешних выводах диода возникает фото-ЭДС Uф. Если замкнуть освещенный фотодиод на некоторую нагрузку, то он будет отдавать в нее полезную электрическую мощность Рэ.
Характеристическими точками вольт-амперных характеристик диода, работающего в таком - фотовентильном - режиме, являются ЭДС холостого хода Uxx и ток короткого замыкания Iкз (рис. 4,б).
Схематически фотодиод в вентильном режиме работает как своеобразный вторичный источник питания, поэтому его определяющим параметром является КПД преобразования световой энергии в электрическую:
КПД = Pэ / APф = aUxxIкз / Apф (2.11)
В фотовентильном режиме действует важный класс фотоэлектрических приборов - солнечные батареи.