 |
|
Тема. Особливості, призначення біполярного транзистора з діодом Шоттки
Біполярний транзистор є поширеним активним елементом у сучасних інтегральних мікросхемах. Структура біполярного транзистора в інтегральних мікросхемах відрізняється від структури дискретного транзистора ізоляцією від підкладки.
Біполярні транзистори мікросхем формуються на напівпровідниковій підкладці p-типу в ізольованих від неї областях n-типу, званих кишенями. Ізоляція кишень від підкладки може бути виконана кількома способами. Самий ідеальний спосіб ізоляції за допомогою діоксиду кремнію, проте, він є технологічно складним (мал.55.1, а). Найбільш простий спосіб ізоляції за допомогою обратносмещенного pn-переходу, але він недосконалий через наявність зворотного струму (мал.55.1, б). Основним методом ізоляції при виробництві інтегральних мікросхем є створення комбінованої ізоляції, що поєднує два попередні (мал.55.1, в).

Мал.55.1 Способи ізоляції кишень від підкладки
Найбільшого поширення набули транзистори, які мають вертикальну структуру, в якій всі висновки від областей транзистора розташовані в одній площині на поверхні підкладки (мал. 55.2). Така структура називається планарної. Структура складається з емітерний 1, базової 2 і колекторної 3 областей. Під колекторної областю розташований прихований n +-шар 4. Від зовнішніх впливів структура захищена діоксидом кремнію 5, в якому є вікна 6 для приєднання металевих висновків 7 до відповідних областей структури.
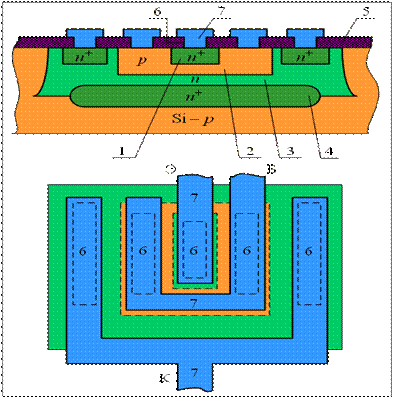
Мал . 55.2 . Структура біполярного транзистора з прихованим n + - шаром
Особливістю даної структури є те , що виведення від колекторної області інтегрального транзистора здійснюється на верхній поверхні кристала. Тому для зменшення об'ємного опору області колектора створюється прихований n + - шар. Однак навіть за наявності прихованого n + - шару опір колекторної області інтегрального транзистора виявляється більше аналогічного опору дискретного транзистора , так як прихований n + - шар відокремлений від колекторного електрода високоомним шаром колекторної області . Це призводить до деякого погіршення частотних властивостей інтегрального транзистора у зв'язку із збільшенням постійної часу ланцюга колектора ( часу перезарядження бар'єрної ємності колектора ) . Тому граничні частоти біполярних транзисторів в інтегральних мікросхемах зазвичай не перевищують . При цьому необхідно також врахувати , що вихідна ємність інтегрального транзистора складається не тільки з бар'єрної ємності колекторного переходу , а й з бар'єрної ємності ізолюючого переходу між областю колектора інтегрального транзистора та іншою частиною кристала.
Основу біполярних інтегральних мікросхем складають транзистори npn - типу , це викликано зручностями формування саме npn -структур і кілька кращими параметрами інтегральних npn - транзисторів у порівнянні з параметрами інтегральних транзисторів pnp - типу.
Справа в тому , що для формування сильнолегованих емітерний областей транзисторів npn - типу зазвичай використовують дифузію фосфору , який має велику розчинність в кремнії і відносно малий коефіцієнт дифузії . Таким чином , для формування pnp - транзистора в інтегральній мікросхемі , яка містить npn - транзистори , необхідно ще провести додаткову дифузію якогось акцептора з граничною розчинністю , що перевищує граничну розчинність фосфору. А такі акцептори практично відсутні.
Тому основним прийнятним варіантом інтегрального транзистора pnp - типу є так званий горизонтальний або бічній транзистор ( мал. 55.3) . Для його формування не треба вводити додаткових технологічних операцій , так як p - області його емітера і колектора виходять одночасно при створенні p - області бази транзистора npn - типу. Однак горизонтальний pnp - транзистор виявляється бездрейфовим через однорідного легування його базової області - епітаксійного шару . Товщина активної частини бази горизонтального транзистора виходить відносно великий . Все це призводить до посередніх частотним властивостям горизонтального транзистора : його гранична частота не перевищує зазвичай декількох десятків мегагерць.

Мал. 55.3. Структура горизонтального транзистора
У горизонтального транзистора повинні бути однаковими пробивні напруги емітерного і колекторного переходів. Близькими повинні бути і коефіцієнти передачі струму емітера при нормальному та інверсному включенні такого транзистора, оскільки області емітера і колектора однакові за властивостями.
Горизонтальна структура дозволяє легко здійснити многоколлекторних транзистор. Для цього достатньо кільцеву область колектора розділити на кілька частин і передбачити окремі висновки від кожної частини - від кожного колектора. Коефіцієнт передачі струму для кожного колектора буде, звичайно, у відповідне число разів менше, ніж для єдиного колектора, але все колектори будуть діяти «синхронно», а навантаження в усіх колекторних ланцюгах будуть електрично розділені. Многоколлекторних транзистор виявляється зручним для деяких цифрових інтегральних мікросхем.
Біполярний транзистор в цифрових інтегральних мікросхемах зазвичай виконує функцію ключа, і весь час працює або в режимі насичення, або в режимі відсічення. У режимі насичення відбувається накопичення неосновних носіїв заряду в базі транзистора, а також у колекторної області. Процеси накопичення неосновних носіїв і їх подальшого розсмоктування при перекладі транзистора в режим відсічення пов'язані з відносно повільним процесом дифузії неосновних носіїв заряду. Інерційність цих процесів визначає швидкість перемикання транзистора з включеного стану у вимкнений і назад, тобто швидкість спрацьовування схеми.
Для прискорення процесу накопичення і розсмоктування неосновних носіїв заряду доцільно обмежити їх накопичення. Досягти цього можна шляхом шунтування колекторного переходу транзистора діодом Шотткі, тобто діодом з випрямляючим електричним переходом між металом і напівпровідником. Структура такого інтегрального транзистора показана на мал. 55.4.

Мал. 55.4. Структура транзистора с діодом Шоттки
Алюмінієвий електрод утворює з p - областю бази омічний перехід , а перехід між алюмінієвим електродом і щодо високоомній n - областю колектора виходить випрямляючим . Через нерівності робіт виходу електронів з алюмінію і з кремнію з електропровідністю n - типу і в результаті хімічної обробки поверхні кремнієвого кристала на контакті для електронів виникає потенційний бар'єр , дещо менший висоти потенційного бар'єру на колекторному переході. Тому при прямому зміщенні колекторного переходу і відповідно при прямому зміщенні діода Шотткі основна частина прямого струму колектора буде проходити через діод Шотткі . Цей струм пов'язаний з рухом електронів з n - області колектора в металевий електрод і не супроводжується інжекцією дірок в n - область колектора. Таким чином , в високоомній області колектора практично не відбувається накопичення неосновних носіїв заряду.
Виготовлення інтегрального транзистора з діодом Шотткі не вимагає введення додаткових технологічних операцій . Необхідно лише змінити відповідним чином фотошаблон , застосовуваний при проведенні фотолітографії для зняття діоксиду кремнію під контакти , і розширити шар напилюваного алюмінію за металургійну кордон колекторного переходу . Однак при знятті діоксиду кремнію в місці виходу колекторного переходу на поверхню монокристала кремнію і при обробці цієї поверхні перед нанесенням алюмінієвої металізації слід запобігти можливість забруднення pn - переходу колектора неконтрольованими домішками.
СРС № 56