 |
|
Технологічні основи електроніки
3 ДИФУЗІЯ ДОМІШОК В НАПІВПРОВІДНИКАХ. МЕХАНІЗМИ ДИФУЗІЇ В ІДЕАЛЬНИХ І РЕАЛЬНИХ СТРУКТУРАХ. ВПЛИВ ДЕФЕКТІВ КРИСТАЛІЧНОЇ ҐРАТКИ НА ПРОТІКАННЯ ДИФУЗІЇ.
Дифузія – це хаотичний потоковий рух під дією прискорюючої сили, наприклад градієнта концентрації.
Ідеальний кристал- кристал без дефектів, домішок і безмежний у просторі. В цьому випадку можлива тільки гомодифузія, а саме два механізми:
 а) Попарний обмін
а) Попарний обмін
б) Кільцевий обмін
Найбільш ймовірний кільцевий обмін. Попарний обмін малоймовірний. Тут потрібна висока синхронність в переміщенні, але й при цьому в області середини обидва атоми дуже сильно деформують гратку, для цього потрібна висока енергія. В кільцевому обміні адіюються багато атомів (від 3), їх повинно одночасно збуджувати, але деформація гратки при цьому значно менша.
В реальних кристалах:
 а) Міжвузільний механізм: атоми міжвузілля дифундують в інше міжвузілля.
а) Міжвузільний механізм: атоми міжвузілля дифундують в інше міжвузілля.
б) Вакансійний: коли біля атома знаходиться вакансія і він може туди перейти.
в) Дисоціативний: атом дифундує по міжвузіллю, при підході к вакансії там локалізує.
г) Витиснення: міжвузільний атом витискує сусіда звузла і займає його місце.
д) Краудіонний (естафетний): поступово естафетне переміщеннясусідніх атомів.
При дифектах:
- Дислокації прискорюють будь який механізм, атоми дифундують швидше вздовж дислокації.
- Поверхня – швидко прискорює дифпроцеси.
- Межа розділу між різними фазами прискорює диф процеси.
8 ПОНЯТТЯ ПРО ІМПЛАНТАЦІЮ. ПРОЦЕСИ, ЩО ПРОТІКАЮТЬ ПРИ ПРОНИКНЕННІ ІМПЛАНТОВАНОГО ІОНА У ҐРАТКУ. ДЕФЕКТОУТВОРЕННЯ ПРИ ІМПЛАНТАЦІЇ.
Імплатація – це процес легування н/п підшарків за рахунок введенняіонів з високою енергією прискорених ел-м полем.
У іонної імплантації є суттєва перевага – точний контрольпроцесу легування і рівномірність введення домішок. Відрізняється від дифузії конкретною направленістю перенесення домішки. Це складний процес, який включає багато простих.
Фізичні процеси:

1) Імплантація іона – іон з високою енергією (Ек>Ев(введення)) одолає Ев, приникуєхться в кристал, постійно долає опір атомів гратки (при цьому втрачає кінетичну енергію), проникає в глиб кристала до тих пір поки його Ек зменшується до 0. В процесі гальмування діють дві основні сили: гальмування ядерне і електронне гальмування.
2) Каналювання – процес коли іон попадає в спеціальні простори, атомні пустоти і рухається по таким пустотам, він втрачає менше енергії і протікає глибше.
3) Дефектоутворення. Рухаючись з великою Ек іон постійно передає Ек гратці, генеруючи фонони (розігрів). Коли Ек>Ев він може вибити атом з вузла міжвузілля, таким чином генеруючи зразу два дефекти: вакансію і міжвузільний атом.
4) Розпилення. Коли іон зразу преедає поверхневому атому велику енергію і імпульс направлений від поверхні, то активно протікає розпилення шарів.
Дефектоутворення обов’язково супутній процес при імплантації. При введені іона на його шляху постійно виникають різні дефекти. Винекнення первинного дефекта може супроводжуватися каскадним винекненням вторинних дефектів. Велике значення має співвідношення маси іонів і каналів гратки:
1) Легкі іони – маса іона менше ніж маса атомів. Вцьому випадку виникають група дефектів грушевидної форми.
2) Важкі іони – маса іона більше ніж маса атомів. Яйцевидна форма
9 Методи окислення плівок Si. Аналіз цих методів. Області їх застосування.
Кінетика окислення кремнія.
Кремній є окисна плівка, тому при окисленні необхідно враховувати процеси дифузії крізь цю плівку. Для окислення необхідно створити окислювальну атмосферу, яка складається з окислювача, розчинника, можливо газо носія. Необхідно постійно підводити окислювач до зразка.
Окислення сухим киснем.
Кисень в процесі абсорбції може дисоціювати на атомарному і дифундувати у вигляді 0, це трохи підвищує швидкість ніж дифузія О2 .При окисленні необхідно враховувати:
- кристалографічну орієнтацію, так як від неї залежить коефіцієнт дифузії.
- Дефектність структури: зростає дефектність – зростає швидкість окислення.
- Концентрація домішки і її хім.. природа.
Окислення в парах води
Для прискорення процесу окислення, в якості окислювача використовують воду. Цей феномен води залежить від наступного:
- вода в кристалі, який має регулярний потенціальний рельєф з більш глибокими ямами.

Таким чином, коли вода проникає в кристал, вона дисоціює на Н і О. Молекули Н дуже спритні, рухливі, тому мають високий коефіцієнт дифузії. Приблизно на 10 порядків більший ніж О.
Н стрибає в сусіднє міжвузілля і тягне за собою О. Таким чином коефіцієнт дифузії кисню О різко підвищується, це скорочує процес зростання плівок. Але на межі розділу вода створює пустоти насичені водою, а також у середині можуть бути пустоти насичені Н2О, це погіршує властивості SiO2 .
Висновок: у воді швидше, але гірше.
Окислення у вологому кисні
Це середній між попередніми випадками. Він має більшу швидкість ніж сухий, але і гірше ніж сухий. Можливо контролювати процентне співвідношення кисню і води. Для цього використовують загальну систему окислення:
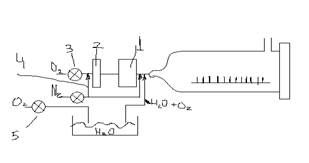
1 – осушувач; 2 – уловлювач пилу; 3 – вентиль; 4 – подача; 5 – кисень проходить через підігріту баню.
Температура окислення як правило близька до температури дифузії. Окислення відбувається разом з дифузією. Частіше суміщають загонку і окислення.
Електролітичне окислення кремнія
При електролітичному окисленні створюється поле в якому переміщуються іони. Це іони кисню і кремнію. Поле прискорює міграцію іонів через SiO2 і дає можливість контролювати процес електродифузії.
Можливе управління постійним полем, постійним струмом.
1) Постійним полем.
В цьому випадку створюється режим постійної напруги. Окисел постійно зростає. А так як товщина SiO2 збільшується, то зростає опір, а струм постійно зменшується. Це впливає на швидкість окислення.
2) Окислення постійним струмом.
Це приводить до підвищення напруги поля Е, яке прикладається до SiO2 ( це дуже погано, бо поле може привести до пробою SiO2). Вибір варіанта окислення залежить від окремих умов.
Плазмове окислення кремнію
В плазмі, яка створена в вакуумі інтенсивно протікають процеси, як іонізації кисню, так і атомізації кисню.
Ці частки більш хімічно активні, але при низьких температурах. Таким чином в плазмі кремній окислюється при низьких температурах і достатньо швидко. Для активізації плазмоутворення в плазму можуть додаватися різні гази.
2 Механізми хімічного травлення напівпровідникових матеріалів. Види хімічного травлення. Вплив структури кристалічної ґратки на швидкість травлення.
Процес хімічної оброботки н/п заключається в розчині їх поверхневого слою під дією кислоти або лужних травників. Данний процес являється гетерогенним, так як взіємодія н/п матеріала з травником здійснюється на границі розділу двох різних середовищ:
- твердої (підшарок);
- рідкої ( травник).
Фіксування температури травника дозволяє реалізувати процес хімічної обробки з постіною швидкістю і таким чином можно розрахувати товщину видаляємого слоя н/п матеріалу.
Але потрібно враховувати той факт, що швидкість травлення слою, порушеного при хімічной обробці не однакова. Швидкість травлення механічно порушеного слою значно велика. Це пояснюється наявністю в механічно порушеному слої великої кількості структурних порушень. Це може бути порушення кристалічної гратки матеріалу, які підвищують ефективну площу взаємодії н/п матеріалу з травником, що призводить до підвищеної швидкості травлення .
Види хімічного травлення:
1) Травлнення Si
Хімічна інертність Si пояснюється наявністю на пластині оксидної плівки, яка розчиняється тільки в лужних розчинах та кислоті. Для цього при хім. обробці Si використовуються 2 види травників: кислотний та лужний.
2) Травлення карбіду Si
Карбід Si дуже стійкий до хімічної взаємодії при температурах до декількох сот градусів цельсія. Для травлення такого матеріалу необхідно щоб в зв'язок вступили кремній та вуглерод.
Найбільш підходящими травниками для карбіду Si являються склади на «»»»»»»»»»»»»» солей та лугів.
3) Травлення арсеніду галію.
Арсенід галію травлять як в лужних так і в кислотних травниках. Полірувальним травником для арсеніда галію являється склад на основі азотної і «»»»»»» кислоти і води , «»»»»»» у відношенні 3:1:2.
4 Іонно-плазмова і плазмохімічна обробка поверхні напівпровідникових матеріалів. Механізми впливу. Області застосування ІПО і ПХО.
Іонно-плазмова обробка кристалів являється одним із специфічних процесів в напівпровідниковій мікроелектроніці, який не потребує використання рідких травників. Суть процесу заключається у взаємодії прискореного потоку іонів інертного газу з поверхнею оброблювального підшарка.
Схема установки для іонно-плазмової обробки:

1-робоча камера; 2-термоімісйний катод; 3-анод; 4-підшарок; 5-плазма.
Для здійснення всього процесу вихідний н/п підшарок розміщують в робочий камері, де виникає тиск інертного газу. За допомогою розміщених в середині камери електродів добиваються стабільного тліючого розряду. Простір заповнений електронно-іонною плазмою. На підшарок відносно плазми подається велике від'ємне значення напруги (-3 кВ).
Врезультаті позитивно заряджені іони плазми бомбардують поверхню підшарка та вибивають атом из поверхні, тобто травлять її.
Плазмохімічна обробка використовується в процессах видалення поверхневого шару матеріала підшарка .який знаходиться в твердій фазі, при взаємодії цього підшарка з плазмою активних газів. В цьому випадку протікає процес реактивного травлення матеріала підшарка.
Процес плазмохімічної обробки відмінний від обробки підшарків іонно-плазмовим методом тим, що видалення речовини з поверхні підшарка проходить не тільки в результаті її її бомбардування позитивно зарядженими іонами плазми, але і в результаті хімічної взаємодії підшарка з активними реагентами плазми.